走査電子顕微鏡、エネルギー分散型X線分光法(SEM-EDX)
SEM;Scanning Electron Microscope
EDS: Energy dispersive X-ray spectrometry
走査電子顕微鏡、エネルギー分散型X線分光法(SEM-EDX)とは
走査電子顕微鏡(Scanning Electron Microscope;SEM)は電子線を利用して試料表面の拡大像を観察する装置です。エネルギー分散型X線分析装置(EDS)と組み合わせて特性X線を検出することにより、特定箇所の元素分析が行えます。
試料や観察目的によって、装置仕様(電子銃や対物レンズの種類)、観察条件(倍率、加速電圧、プローブ電流、作動距離(WD)等)、検出器(二次電子/反射電子/特性X線)等を適切に選択することにより、表面微細構造、凹凸形状、組成、結晶粒径等の材料中の様々な情報を引き出すことができます。
走査電子顕微鏡、エネルギー分散型X線分光法の特徴
- 波長が短い電子線を用いて結像するため、光学顕微鏡よりも高倍率・高分解能で試料の表面・断面を観察することができます。
- 光学顕微鏡と比較して焦点深度が十分に深いため、破断面等の凹凸の大きい試料を立体的に観察できます。
- 加速電圧や検出信号(二次電子/ 反射電子)等を適切に選択することで、凹凸形状や組成の違いを強調して観察できます。
- 電子線照射によって発生した元素に固有な特性X線を、エネルギー分散型X線分光装置(EDS)で検出することにより元素分析が可能です(SEM-EDS)。
- 低加速電圧観察(≦2kV)で、試料最表面の微細構造を観察できます。
- 試料表面で回折を受けた反射電子を検出して結晶方位分布を解析できます。
- SEM画像による形状測定と元素分析を組み合わせて、複数の粒子について詳細に解析することができます。
- 低真空SEMにより、絶縁物試料や水分・油分を含む試料を無蒸着で観察・分析できます。


分析例
・走査電子顕微鏡(SEM)による観察例
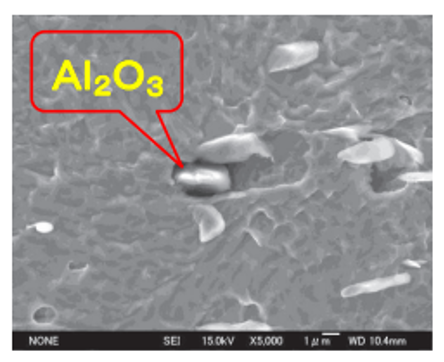
・エネルギー分散型X線分析装置(EDS)による元素マップ例
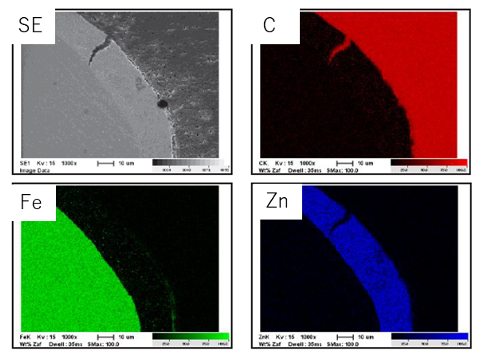
走査電子顕微鏡、エネルギー分散型X線分光法の適用分野
各種材料の表面/断面形状観察および組成分析
- 鉄鋼材料、非鉄金属の組織観察(粒界、双晶、析出物、介在物)
- 接合界面における合金層形成状態の評価
- めっき、多層膜等の層構造観察および膜厚測定
- 異物、変色部の元素分析
- 破断面観察による破損原因調査
- 介在物、粉体等の粒度分布解析
1.走査電子顕微鏡(SEM: Scanning Electron Microscope)
・走査電子顕微鏡(SEM)の原理
真空中で数100V~30kVに加速された細い電子線(電子プローブ)を試料に照射すると、試料を構成する原子核や電子との相互作用により、表面から二次電子・反射電子・特性X線等の電子やX線が放出されます。電子銃から発生させた電子プローブを偏向コイルで二次元的に走査しながら、二次電子や反射電子の強度を検出して画像を構築することで、試料表面形状を観察できます。
SEM像の結像には、一般的に二次電子と反射電子が用いられ、それぞれ以下のような特徴があります。
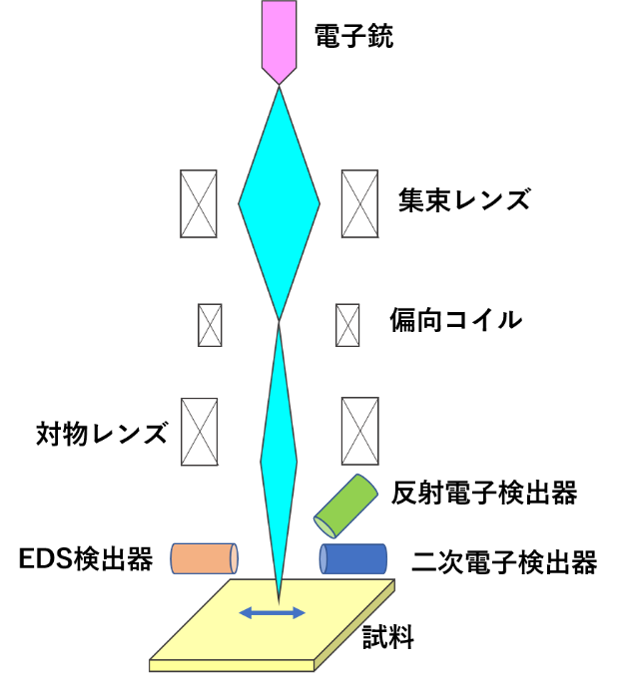
二次電子
二次電子は試料表面付近の原子を励起して放出されるエネルギーが50eV以下の電子のことを指し、突起・エッジ部、傾斜部で信号量が多くなるという特徴があるため、二次電子像は、主に試料の凹凸形状を反映しています。
反射電子
反射電子は、入射電子と試料構成原子との相互作用によって、試料表面から数100nmの領域から飛び出した電子で(後方散乱)、原子番号が大きいほど信号量が多い性質を持っているため、反射電子像のコントラストの明暗から、試料の組成の違いを可視化することができます。また、反射電子の信号量は、結晶方位に依存するので、多結晶試料(金属等)の結晶方位の違いや粒径を調べることができます(チャネリングコントラスト)。
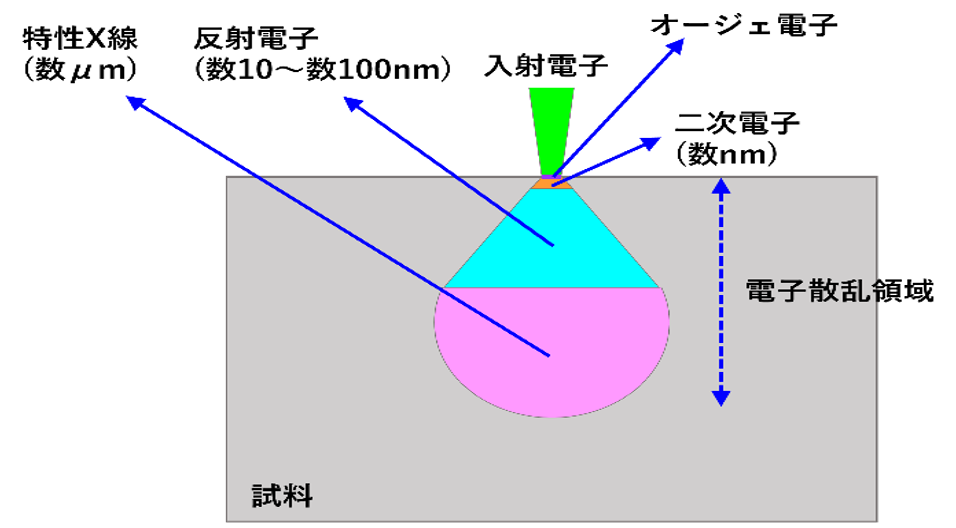
2.エネルギー分散型X線分析(EDS: Energy dispersive X-ray spectrometry)
・エネルギー分散型X線分析(EDS)の原理
入射電子が内殻軌道電子を弾き出し、電子軌道に空孔ができると、安定化のため外殻軌道電子が空孔に落ち込みます。この過程で、両軌道のエネルギー差に相当するX線(特性X線)が発生します。特性X線のエネルギーは元素固有のものであるため、これを半導体検出器で検出し、エネルギー毎に信号処理することでSEM観察領域内の特定箇所の元素・組成分析ができます。
得られたスペクトルの特性X線のエネルギー(ピーク位置)から、測定位置の試料構成元素(B~U)を調べることができます(定性分析)。また、特性X線の強度から各元素の質量・原子数濃度計算(半定量分析)、観察視野内における元素分布測定(マッピング)等の解析も行なうことができます。
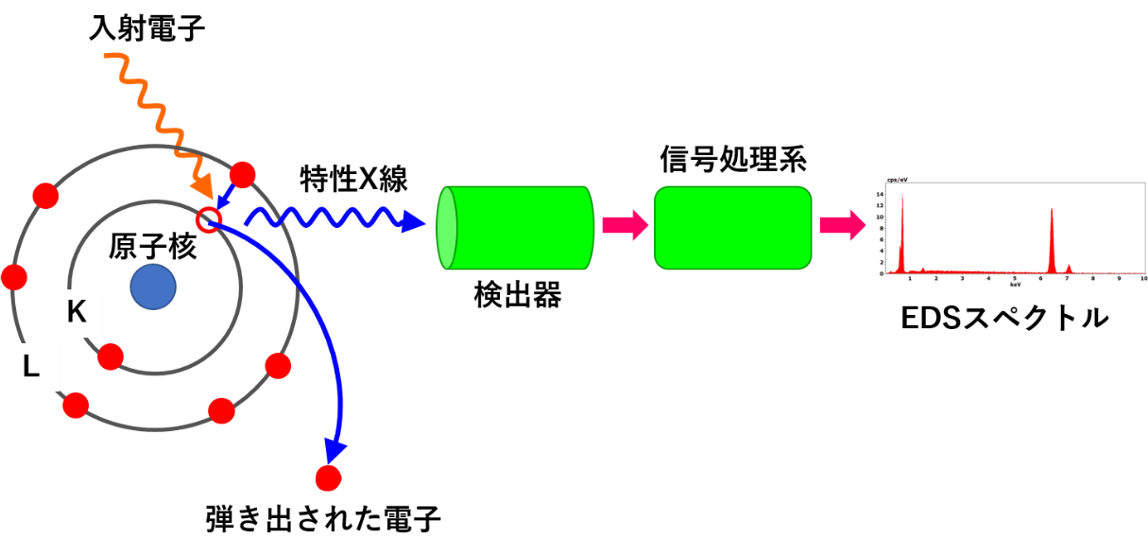
エネルギー分散型X線分析(EDS)の特徴
- 測定可能元素:B~U
- 多元素同時測定が可能(未知試料の分析に最適)
- 検出深さ:数100nm~数μm(加速電圧、元素により異なる)
- エネルギー分解能:130~140eV
- 検出下限:0.5%程度(金属の場合)
装置仕様(一例)
| 電界放出形走査電子顕微鏡 (FE-SEM) | 電子銃 | ショットキーエミッション型 |
| 倍率 | 数10倍~約200,000倍 | |
| 加速電圧 | 数百V~30kV | |
| 検出器 | 二次電子,反射電子 | |
| オプション | EDS,EBSD検出器 | |
| その他、汎用型SEM (W-SEM)、低真空SEM等各種仕様の装置をとりそろえております。 | ||
サンプル仕様
| 観察及び分析対象 | 固体材料全般 鉄鋼材料、非鉄金属、電池材料、半導体、セラミックス、ガラス、樹脂材料、粉体、複合材料等 |
| 推奨試料サイズ | 30mmΦ,高さ20mm以内程度 ※装置によって異なります。大型試料投入可能なSEMも保有しておりますので、ご相談ください。 |
| 試料の前処理 |
良好なSEM像を得るためには、目的に応じた前処理が必要です。
|
走査電子顕微鏡、エネルギー分散型X線分光法の事例
事例1;低加速電圧SEMによるPt/C触媒の形態観察
低加速電圧・高分解能SEM観察により、燃料電池用Pt/C触媒層のカーボン担体最表面形状とPt粒子担持状況がわかります。

事例2;Al-Znめっき鋼板の断面組織観察
FIBを用いてAl-Znめっき鋼板の断面出しをして、めっき層の反射電子像観察とEDS点分析、線分析、元素マップ測定を行いました。
反射電子像は重元素ほど明るいコントラストを示す性質があるため、EDS元素分析結果との対比により、それぞれ白色相がZn相、マトリックスのグレー相がAl相、黒色相がSi析出物に対応しています。
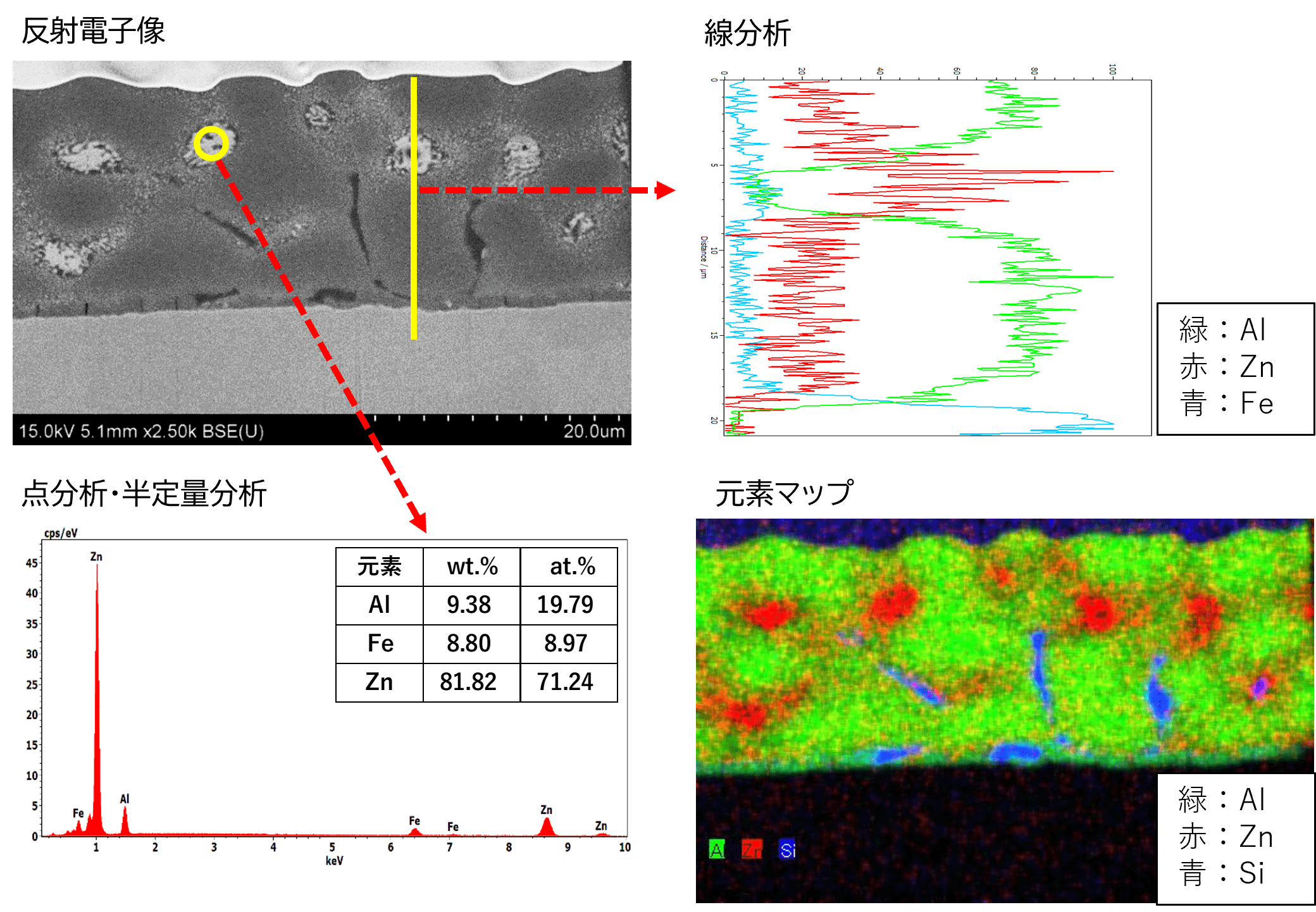
事例3;ボルトの破面観察
SEMは焦点深度が深いため、破断面等の凹凸がある試料の表面観察が容易に行うことが可能です。
破面形状から破断の種類を特定し、破損原因を調査することができます。
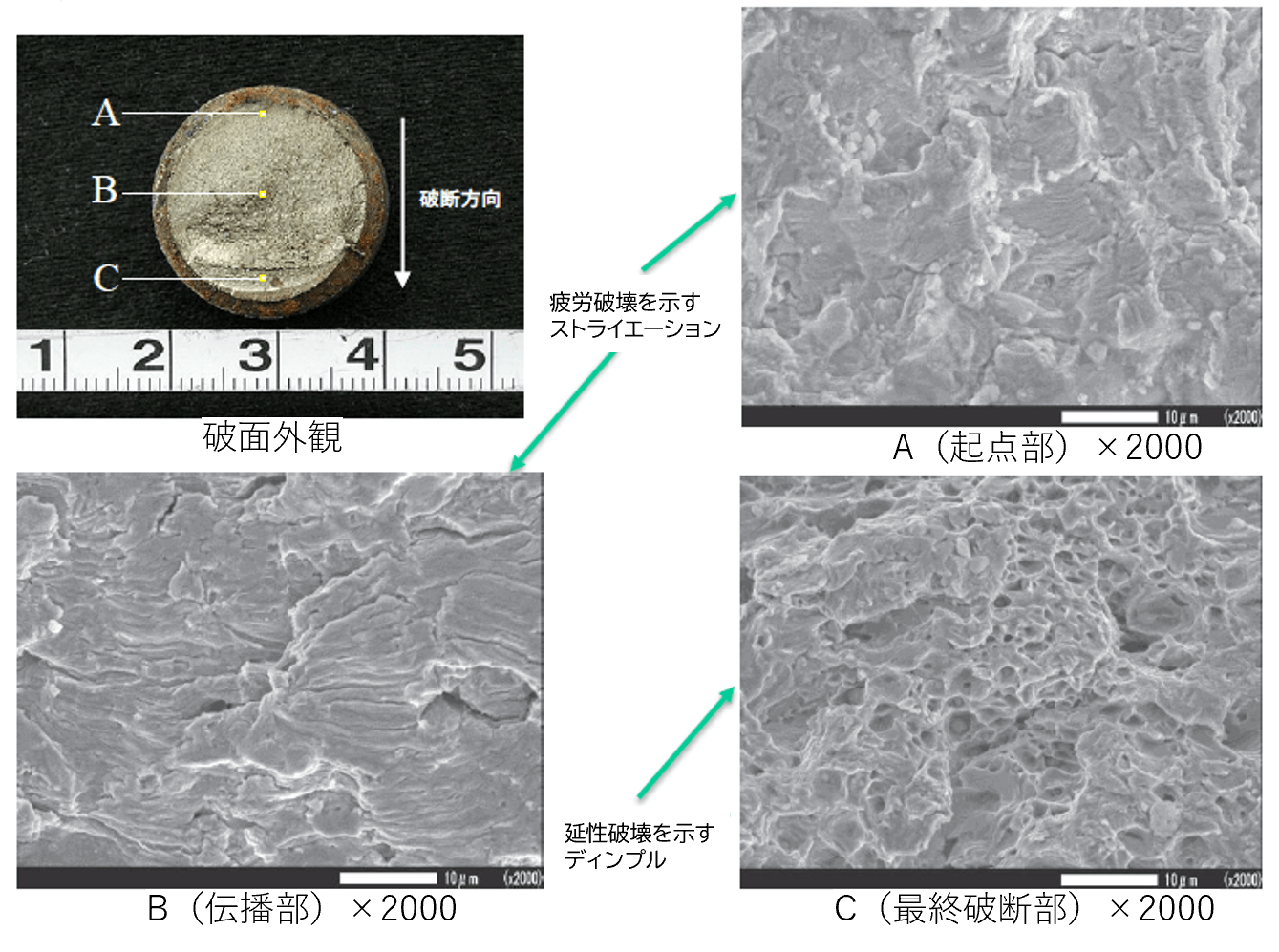
このボルトの破面は、金属疲労により上部からくり返し応力で破壊が進行しており、最終的に延性破断により下部で破壊したものと推定されます。
事例4;電子基板の不具合調査(低真空SEMによる絶縁物の観察・分析)
SEMを用いて非導電性試料(絶縁物)を観察する場合、通常は前処理としてAu,Pt,C等の導電性物質を蒸着し、高真空(1万分の1Pa)状態で観察します。
蒸着により変質させたくない試料や、高真空により変形する試料、水・油等の揮発成分を含む試料には、試料室内を10Pa~100Pa程度に制御することにより、前処理が不要となる「低真空SEMによる観察」が有効です。
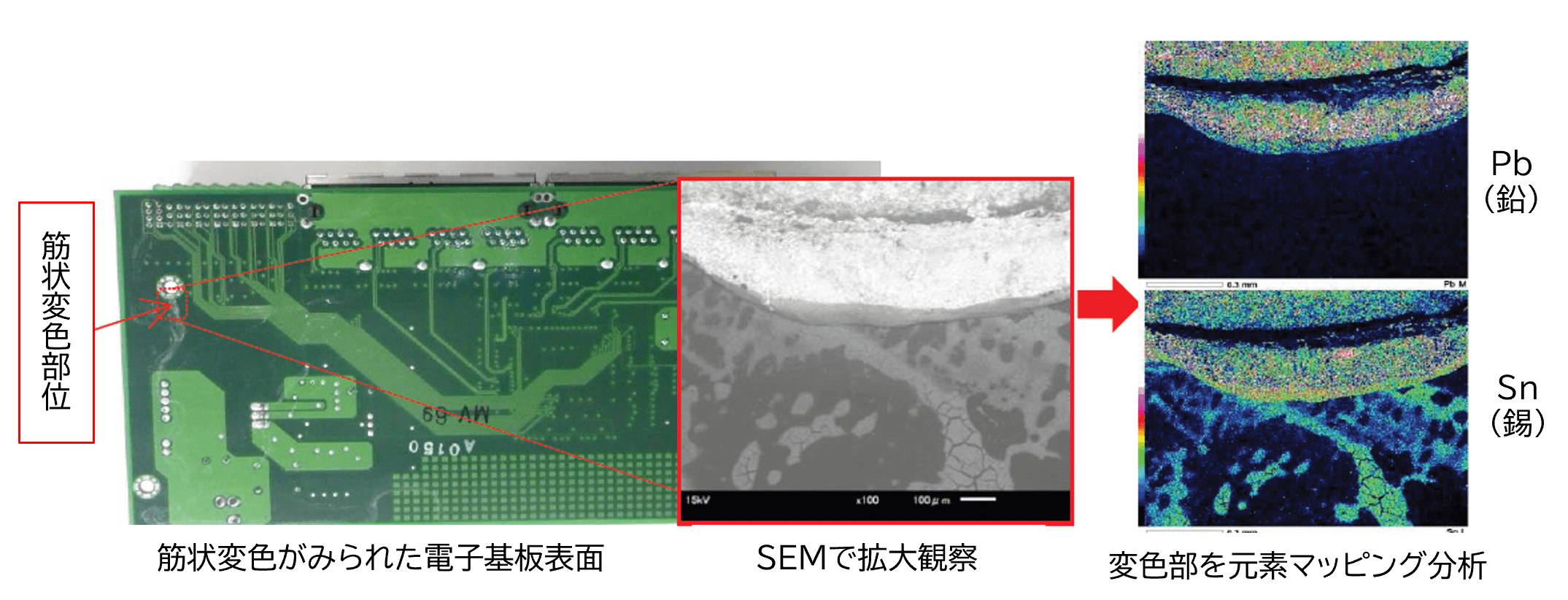
電子基板の不具合(導通不良)の原因を低真空SEM-EDSを用いて調査した事例です。
筋状変色が見られた部分(写真1)を、前処理無しでそのまま拡大観察すると付着物が確認できます(図1)。元素マッピングの結果、付着物からSnが多く検出されました(図2)。よって、ハンダ中のSnが結露によって選択腐食され、流れて、導通不良に至ったと推測されます。
また、必要に応じて、低真空SEM観察後の試料をフーリエ変換赤外分光分析や微小部X線回折測定等で調査を行う事も可能です。

