集束イオンビーム加工(FIB)
FIB:Focused Ion Beam
集束イオンビーム加工・観察とは
集束イオンビーム装置(FIB:Focused Ion Beam)は、試料の微細加工・観察を行う装置です。主に透過電子顕微鏡(TEM)の薄片試料作製のために利用されます。走査電子顕微鏡(SEM)を搭載したFIB-SEM複合装置では、TEM薄片作製のほか、特定箇所の断面加工・観察や三次元観察が可能です。
FIBの加工・観察イメージ
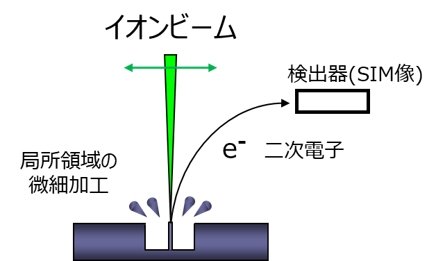
集束イオンビーム加工 FIBの原理と特徴
集束したイオンビームを試料に照射してスキャンさせることで、二次電子像の撮影やスパッタリングによる試料加工が行えます。次のような特長があります。
- 走査イオン顕微鏡像(SIM像)を取得できます。
- 高い位置精度で関心領域の微細加工が可能です(<100nm)。
- 機械加工やイオンミリングと比較し、加工ダメージや凹凸が低減できます。
- 冷却加工機能により、熱に弱い試料の加工も行えます。
FIBによるTEM試料作製の手順
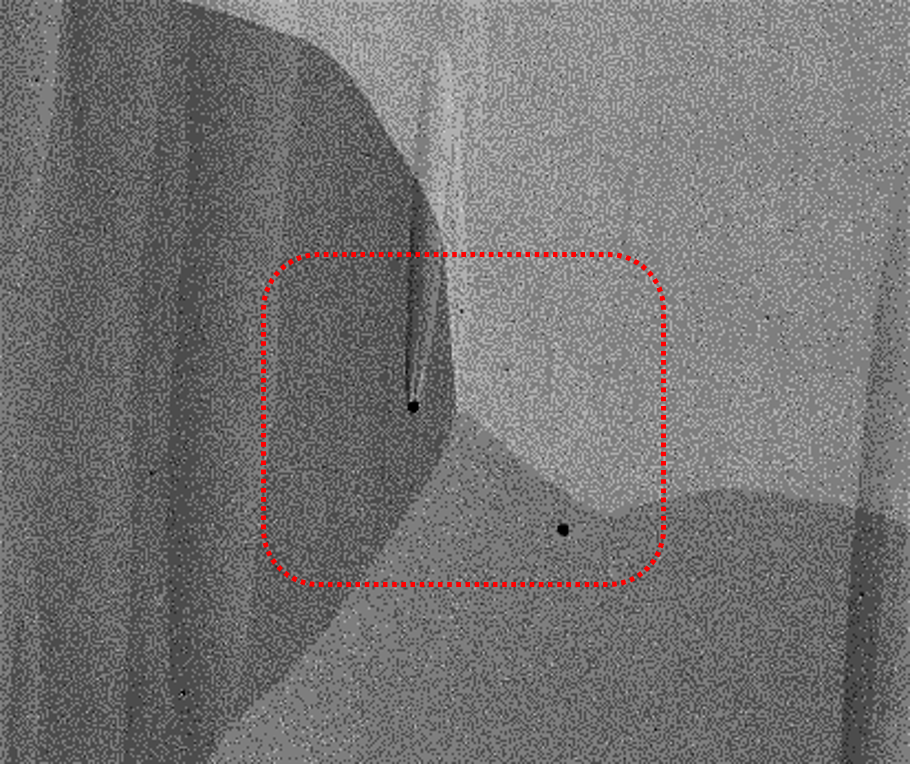
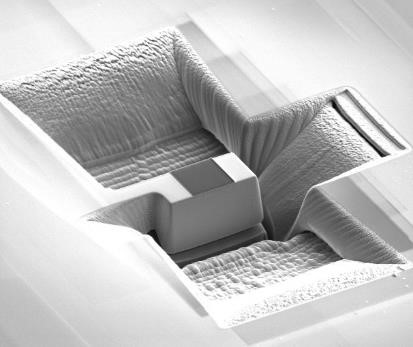
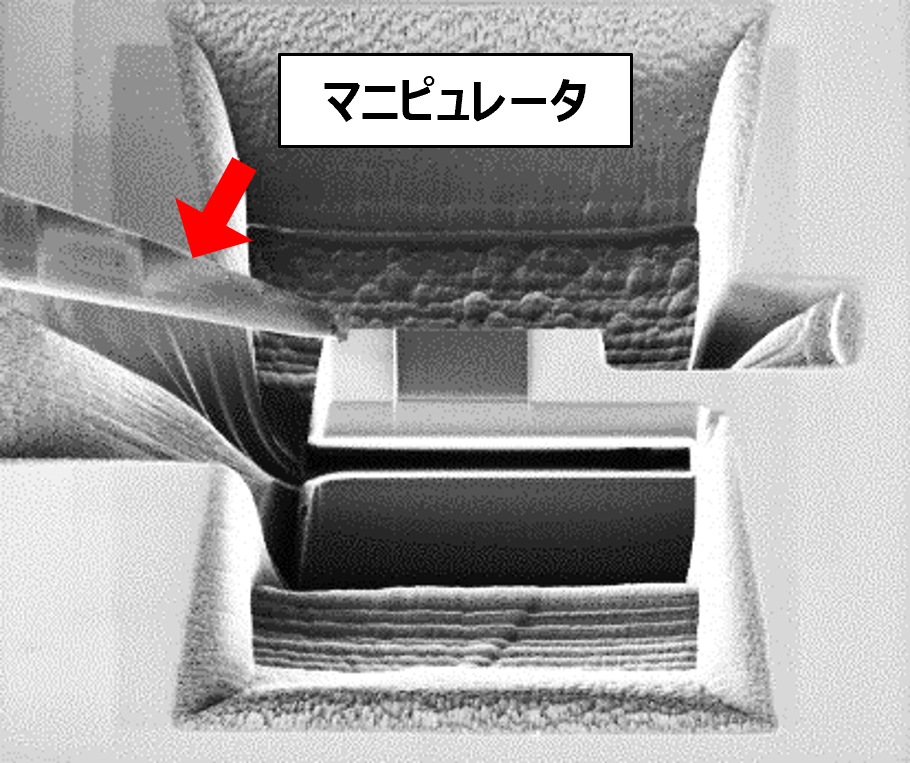
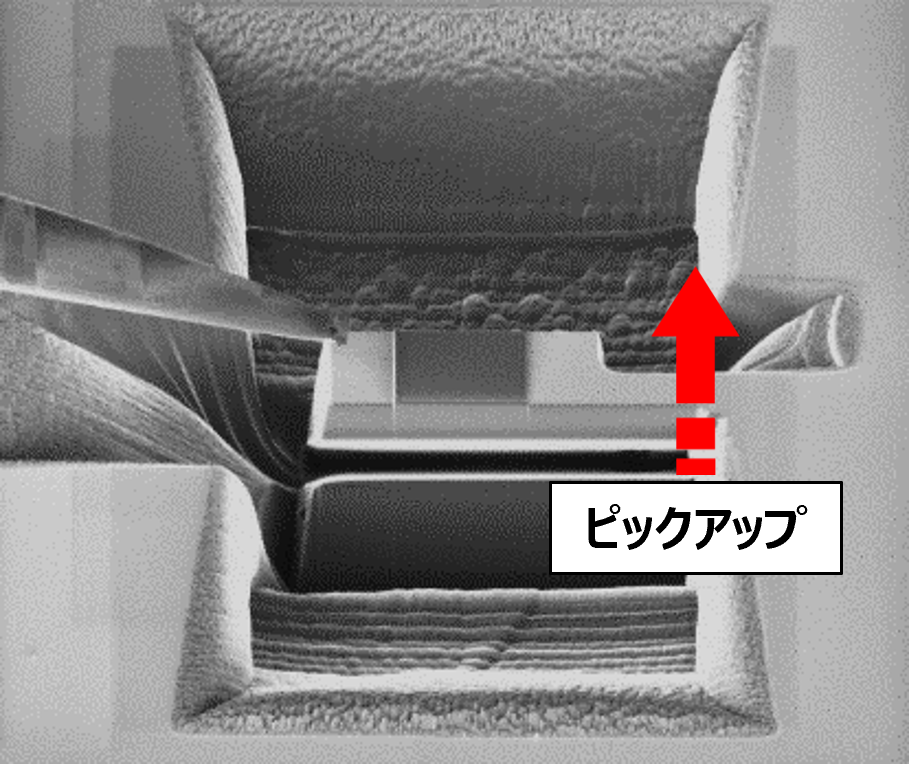

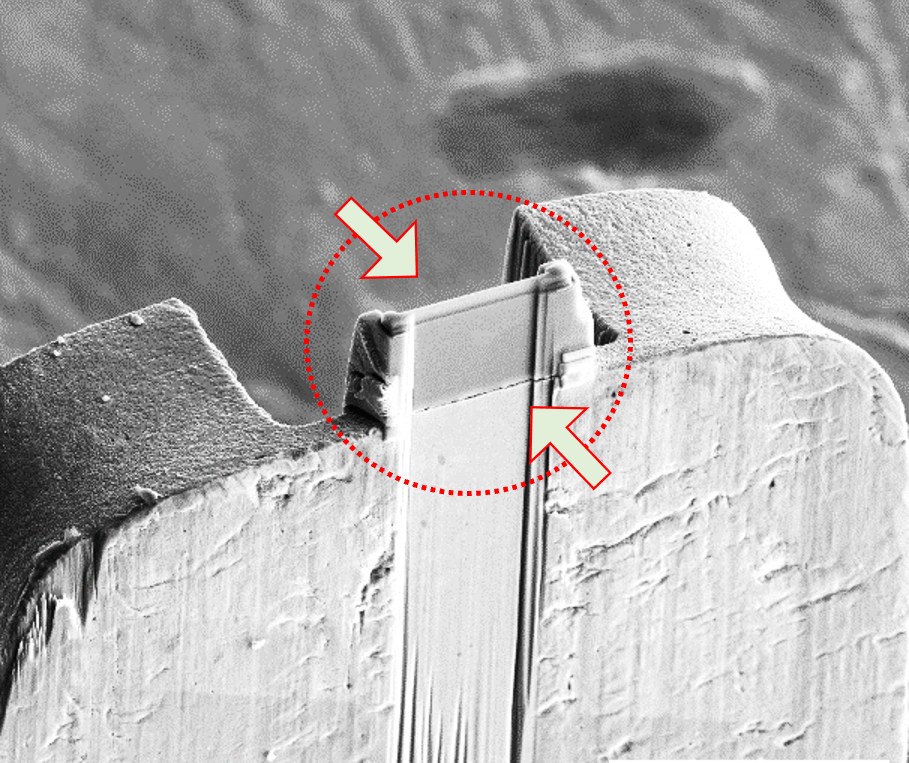
適用事例
- TEM観察用試料の薄片作製
- SEM断面観察用試料の作製(FIB-SEM装置でそのまま観察も可能)
- その他μm~数十μmサイズの試料加工
適用材料
- 金属、半導体、電池材料、ソフトマテリアル等
- マルチマテリアル界面部の加工・観察
- 試料最表面の異物や異材の観察・分析
(含水性・脱ガス性がなく、真空装置に導入できるもの)
装置仕様
| FIB | イオン源 | Ga液体金属イオン源 |
|---|---|---|
| 加速電圧 | 1~40kV | |
| SEM | 検出信号 | 二次電子、反射電子、走査透過電子(STEM) |
| 加速電圧 | 0.5kV~30kV | |
| その他機能 | エネルギー分散型X線分析(EDS) | |
| 試料大気非暴露冷却(Min-140°C) | ||
| 導入可能試料サイズ | φ32mm × H20mm(通常加工時) | |
| 最大φ3mm未満(非暴露冷却加工時) | ||
※その他クライオFIB装置、プラズマFIB-SEM装置などを所有しています

事例;Zn-Al-Mg系めっき鋼板の断面観察試料作製
- FIB-SEM装置では試料の表面と断面で対応した情報を取得できます。
- 微細な組織、異物や欠陥などを狙った加工観察も可能です。
- 元素分析(エネルギー分散型X線分析;EDS)にも対応しています。