プラズマFIB-SEMによる三次元観察 (PFIB-SEM)
PFIB-SEM; Plasma Focused Ion Beam Scanning Electron Microscopes
プラズマFIB-SEMによる三次元観察(PFIB-SEM)とは
FIB-SEM装置は試料の微細加工機能(集束イオンビーム:FIB)と観察機能(走査電子顕微鏡:SEM)が一体化された装置で、TEM等の試料作製や試料断面の加工観察に加え、三次元加工観察を行うことができます。プラズマイオン源FIBは、従来のGa-FIBの数十倍の加工能力を有しており、より広い領域の断面観察試料作製・三次元解析が可能です。
プラズマFIB-SEMによる三次元観察(PFIB-SEM)の原理・特徴
当社のプラズマFIB-SEMは、従来のGa-FIBと同様の機能に加え、以下の特長を有します。
- ガリウムフリーなTEM試料を作製可能
- マルチイオンプラズマFIBカラムにより材料特性に応じた加工・解析が可能(Xe,Ar,O)
- 高分解能・大容積の3D SEM-EDSデータを取得できます
- 大気非暴露搬送システムを搭載
Gaイオン源とプラズマイオン源の違い

プラズマFIB-SEMによる三次元観察(PFIB-SEM)の適用分野
【適用事例】
- TEM観察用試料のガリウムフリー作製
- FIB-SEMによる三次元観察
- X線CT等の関心領域の詳細観察・分析
- その他の数十μm~サイズの試料加工
【適用材料】
- 金属、半導体、電池材料、ソフトマテリアル等
- マルチマテリアル界面部の加工・観察
- 試料最表面の異物や異材の観察・分析
(含水性・脱ガス性がなく、真空装置に導入できるもの)
装置仕様
| 装置 | マルチプラズマイオン源FIB-SEM Helios Hydra FEI社製 |
|
|---|---|---|
| FIB仕様 | イオン源 | プラズマイオン源 |
| イオン種 | Xe、Ar、O、Nから選択 | |
| 加速電圧 | 500V~30kV | |
| SEM仕様 | 検出信号 | 二次電子、反射電子 |
| 加速電圧 | 350V~30kV | |
| その他機能 | エネルギー分散型X線分析(EDS) | |
| 試料大気非暴露搬送システム | ||
| 導入可能試料サイズ | 最大φ110mm程度 | |
プラズマFIB-SEMによる三次元観察(PFIB-SEM)の事例
事例1:広域断面加工・観察
PFIB-SEMは、Ga-FIBの数十倍のビーム電流を実現し、従来は数十μm角だった加工範囲を数百μmオーダーまで拡大できます。これにより、広域の断面観察を高位置精度で行うことが可能です。
IC製品のワイヤボンディング部をPFIBで断面加工したSEM像では、接合界面の形状からワイヤの結晶組織まで一断面で評価できています。
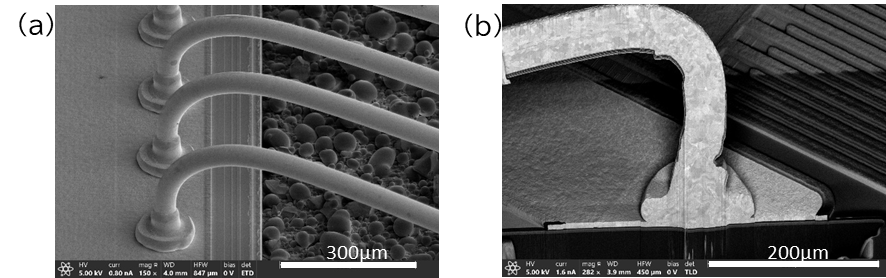
事例2;PFIBのGaフリー加工によるTEM試料作製
アルミ材粒界部をFIBにより薄片を作成し、TEMによる面分析・線分析を行った事例を示します。
Ga-FIB加工では粒界部でGa(加工イオン)が濃化している一方、Ar-PFIBでは加工イオンの影響は非常に小さいことが分かります。PFIBによる試料作製は信頼性の高いTEMデータの取得に貢献します。
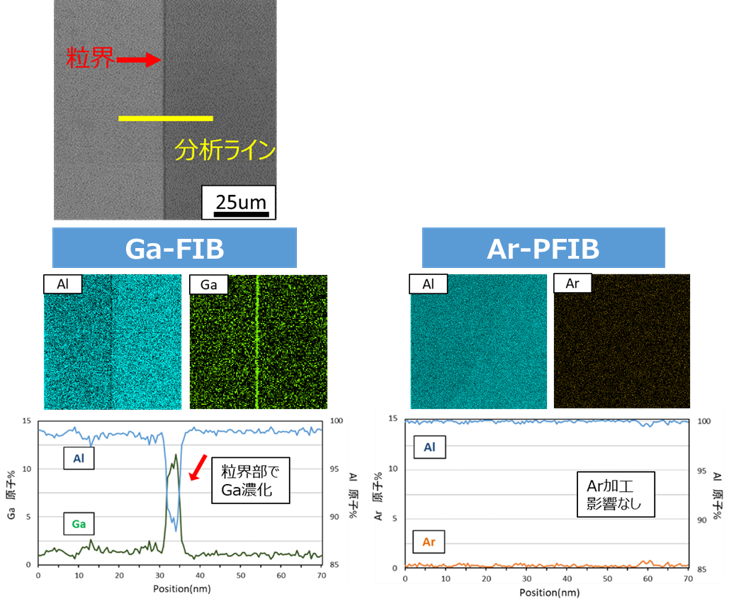
事例3;プラズマFIBを用いた三次元解析事例
FIB-SEMの三次元解析は、FIBによる試料加工とSEMによる断面観察を繰り返し、その画像をソフトウェアにより三次元再構築する手法です。
試料構造を立体的に観察でき、相構造や空隙、欠陥などを定量的に解析できます。
FIB-SEMによる三次元観察手法
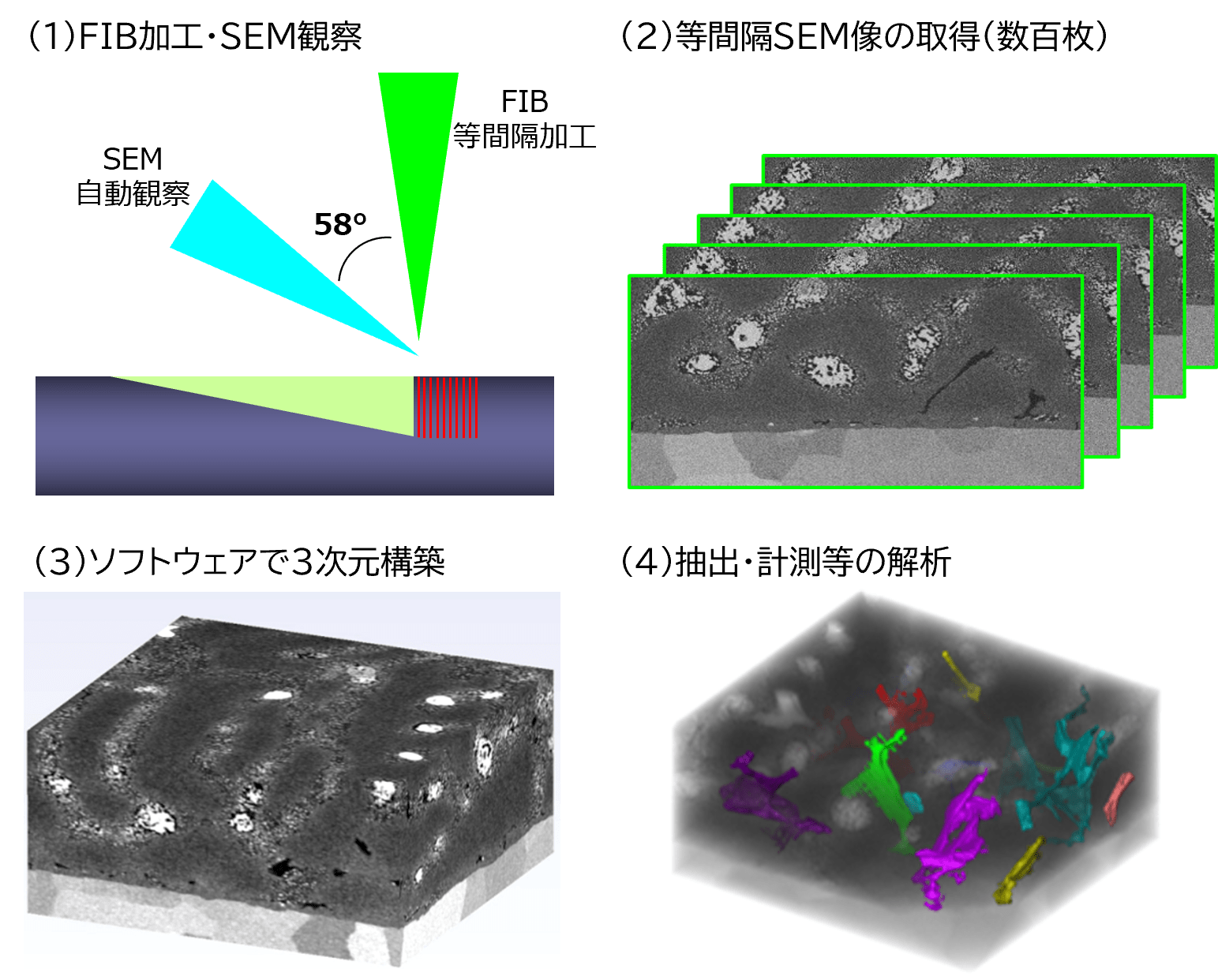
GaFIBとPFIBによるめっき鋼板の3D観察体積の比較
プラズマFIBとGaFIBによるめっき鋼板の三次元観察の事例を示します。
加工力の大きいPFIBではGaFIBの数十~千倍の加工体積を取得でき、従来のGaFIBでは不可能だった広い領域の観察や、統計的に優位なデータの提供が可能です。