飛行時間型二次イオン質量分析(TOF-SIMS)
TOF-SIMS:Time-of-Flight Secondary Ion Mass Spectrometry
飛行時間型二次イオン質量分析(TOF-SIMS)とは
飛行時間型二次イオン質量分析(TOF-SIMS)はパルス化した一次イオンビームを試料表面に照射し、その表面から放出された二次イオンを飛行時間により質量分離を行う手法です。試料最表面に存在する無機・有機成分に関する情報を高感度に得ることができ、表面汚染物質の分析、微量添加元素も含むマッピングが可能で、深さ方向分析も可能です。
飛行時間型二次イオン質量分析装置(TOF-SIMS)の外観

飛行時間型二次イオン質量分析(TOF-SIMS)の原理
試料表面に一次イオンを照射すると、その表面からスパッタリング現象によって正または負の二次イオンが放出されます(図1)。
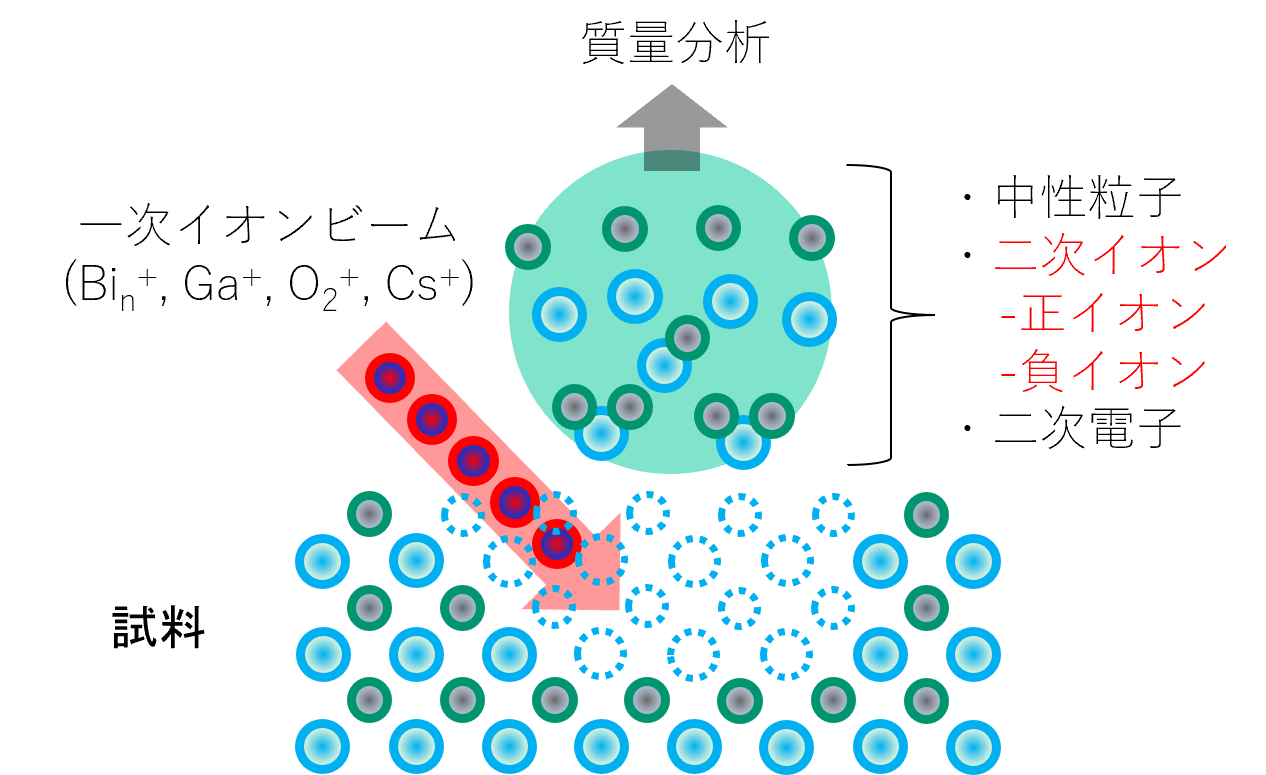
この二次イオンを引き出し電圧によって加速し、検出器に到達するまでの飛行時間を質量に換算することで、試料情報を得ることができます(図2)。
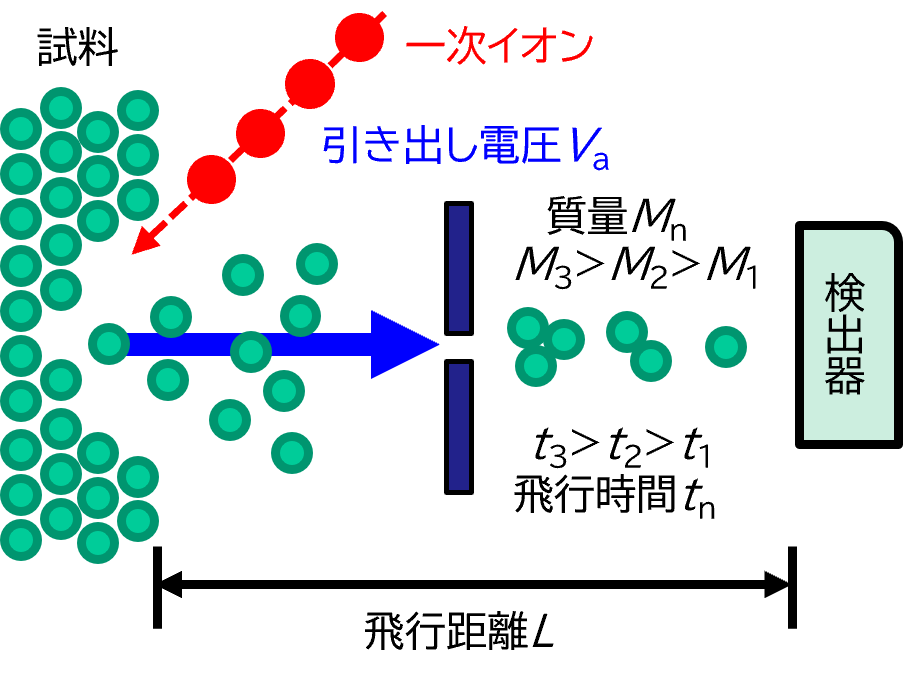
装置仕様
| 一次イオン銃 | Bi(Bi1+、Bi3+、 Bi3++)、Ar-GCIB |
| 分析領域 | 20μm×20μm~500μm×500μm *ステージスキャンで最大60mm×60mm |
| 最小ビーム径 | 80nm(高空間分解能測定時) |
| 画素数 | 128pixel×128pixel~2048pixel×2048pixel |
| 情報深さ | 1~3nm |
| 検出感度 | 数ppmオーダー *元素、マトリクスによる |
| 測定質量範囲 | m/z 0~10,000、全質量範囲の同時測定が可能 |
| 質量分解能 | 10,000以上 *高質量分解能測定時 |
| スパッタイオン銃 |
|
| 試料サイズ | 16mm×12mm、8mmt以下(バックマウント) 90mmφ、12mmt以下(トップマウント) |
| その他 | Zalar試料回転対応 |
飛行時間型二次イオン質量分析(TOF-SIMS)の特徴
- ●最表面(数原子層)の情報が得られる
- ●高感度である(最大数ppmオーダー)
- ●全元素(H~U)および同位体の測定が可能
- ●空間分解能が高い(ビーム径:80nm~)
- ●質量範囲が広く(M/z 0~10,000)、質量分解能が高い(M/⊿M >10,000)
- ●表面の化学構造情報が得られる
- ●絶縁物の測定が容易である
飛行時間型二次イオン質量分析(TOF-SIMS)の適用分野(用途)
- ●ポリマー、有機無機多層膜:異物分析、構造解析、反応解析、添加材等の面内分布あるいは深さ方向分布など
- ●半導体:最表面の微量金属分析、不純物分析、微小部のドーパント深さ方向分析など
- ●金属:微量成分の偏析・拡散の評価(B、C、Sなど)、摺動被膜解析、腐食被膜解析など
- ●電子部品:汚染分析、残渣分析、接着不良解析など
注意点
- ●試料組成によって検出強度に差異が生じるため、定量化を行う場合は同一組成での標準試料が必要となります
- ●二次汚染回避のために試料の取扱いにつきまして、以下の点にご注意下さい
・手で触れない、清浄な手袋、ピンセットを使用する
・直でポリ袋に入れない、ケースに入れるまたはアルミホイルで包む
・マーキングをする場合は、マジックではなくケガキ
・テープで固定する場合は、使用を最低減に抑える - ●粉末はスパチュラ3杯以上をご用意ください
- ●絶縁性のあるサンプルの場合、16×12mm、8mmt以下でご用意ください(ご相談可能)
- ●脱ガスのあるサンプルの場合、10mm× 10mm、5mmt以下でご用意ください(ご相談可能)
分析項目
1)定性分析
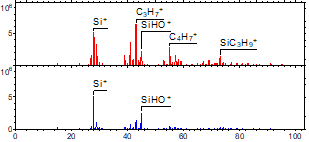
得られたマススペクトルから定性評価が可能です。
2)マッピング分析

元素、化合物の面内分布を観察できます。
3)深さ方向分析
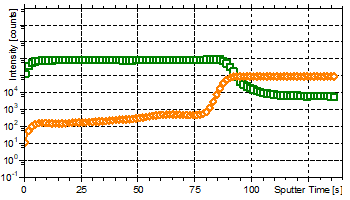
各種スパッタイオン銃の併用により、深さ方向分析が可能です。
飛行時間型二次イオン質量分析 (TOF-SIMS)による評価事例
事例1;微量元素のマッピング分析
対象試料:ホウ素10ppm添加鋼
高空間分解能および高感度検出により、微量元素の面内分布を観察することができます。更に走査イオン像による組織観察も可能です。
分析例では、鋼中の微量な添加元素であるホウ素(B)が結晶粒界に偏析していることを確認できます。

事例2; Siウェハ表面の性状調査
対象試料:ポリ袋に保存したSiウェハ、ポリ袋、清浄なSiウェハ
フラグメントイオン(元の化学構造が分解されたイオン)により、有機物の化学構造解析が可能であり、最表面の有機汚染の調査に非常に有効です。
分析例では、ポリ袋に保存したSiウェハからは、ポリ袋の滑剤として使用されるステアリン酸アミドが検出され、ポリ袋由来の成分が転写されていることがわかります。
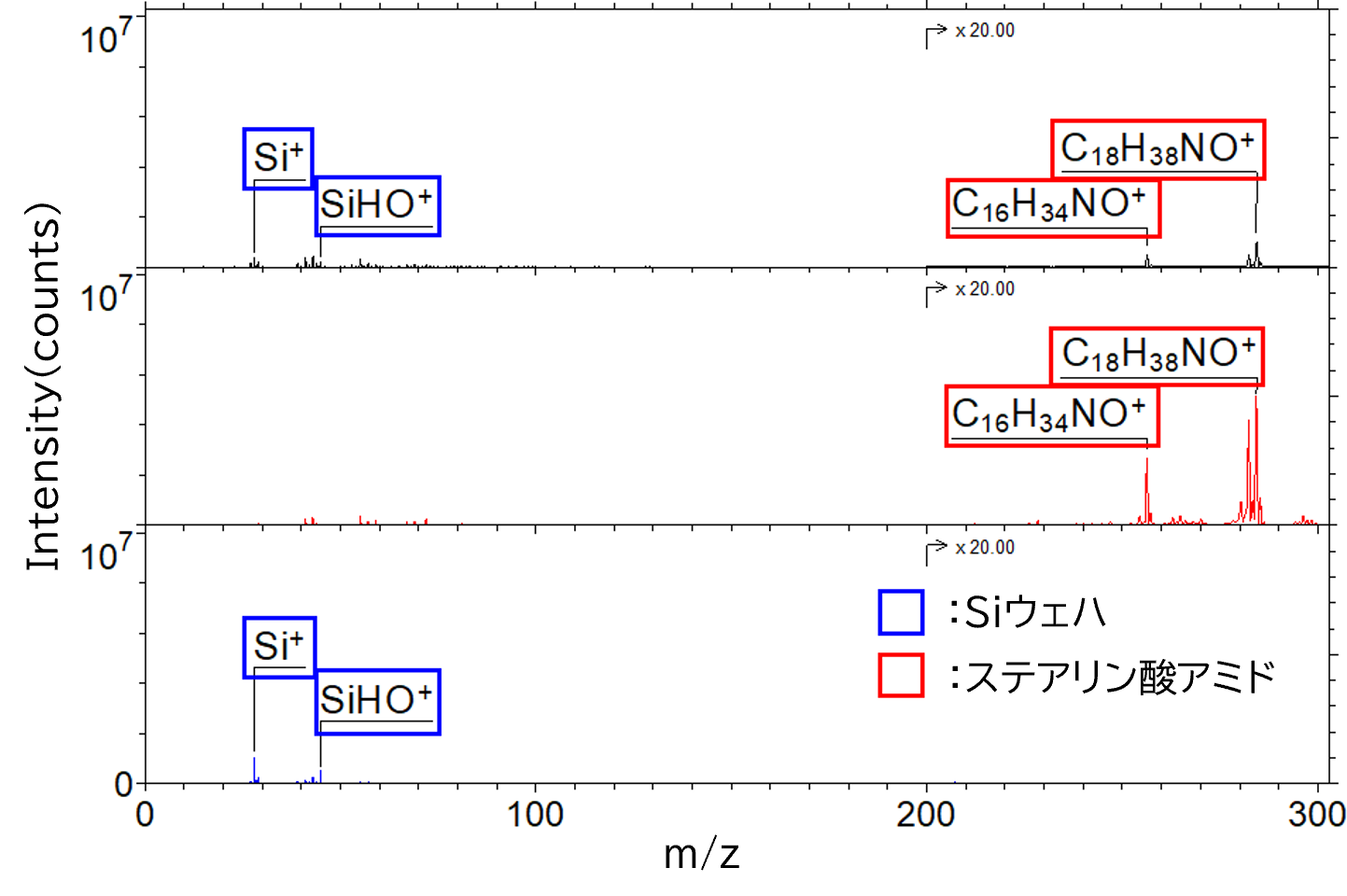
事例3; 塗膜の斜め断面分析
対象試料:塗装鋼板
微小領域の有機・無機成分に関する情報を一度に取得可能です。また、表面界面切削解析装置(SAICAS)を用いて作製した斜め断面をTOF-SIMS分析することで、ミクロンオーダー以下の塗膜内部や界面の詳細解析が可能です。
分析例では、塗装鋼板の斜め断面のマッピング分析を実施しました。ポリエステル樹脂中にフィラー成分と推測されるSiやCaが粒状に分布していることが確認できます。


