電子部品の信頼性評価
電子部品の信頼性評価とは
.電子部品・電子材料などの特性評価、信頼性評価・不良解析を行っています。評価項目は電気特性と機械・熱特性です。
各種雰囲気や環境条件の下で特性評価をすることで、信頼性評価や寿命試験ができます。更に、寿命試験終了後、劣化・変質した試料の断面観察、表面観察、界面組成などの分析により、寿命原因の解明を行います。
また、自動車関連に使用される材料の電気、機械特性の評価や、開発試作品の通電試験、振動試験、および複合環境試験についても対応しています。
1.電気配線間のイオンマイグレーション性評価試験
電子基板の高密度化に伴い、配線の狭ピッチ化と絶縁層の薄膜化が一層進んだことにより、電気配線の健全性・劣化性評価のニーズが増えています。この評価手法のひとつとして耐イオンマイグレーション性評価が挙げられます。
イオンマイグレーションの模式図
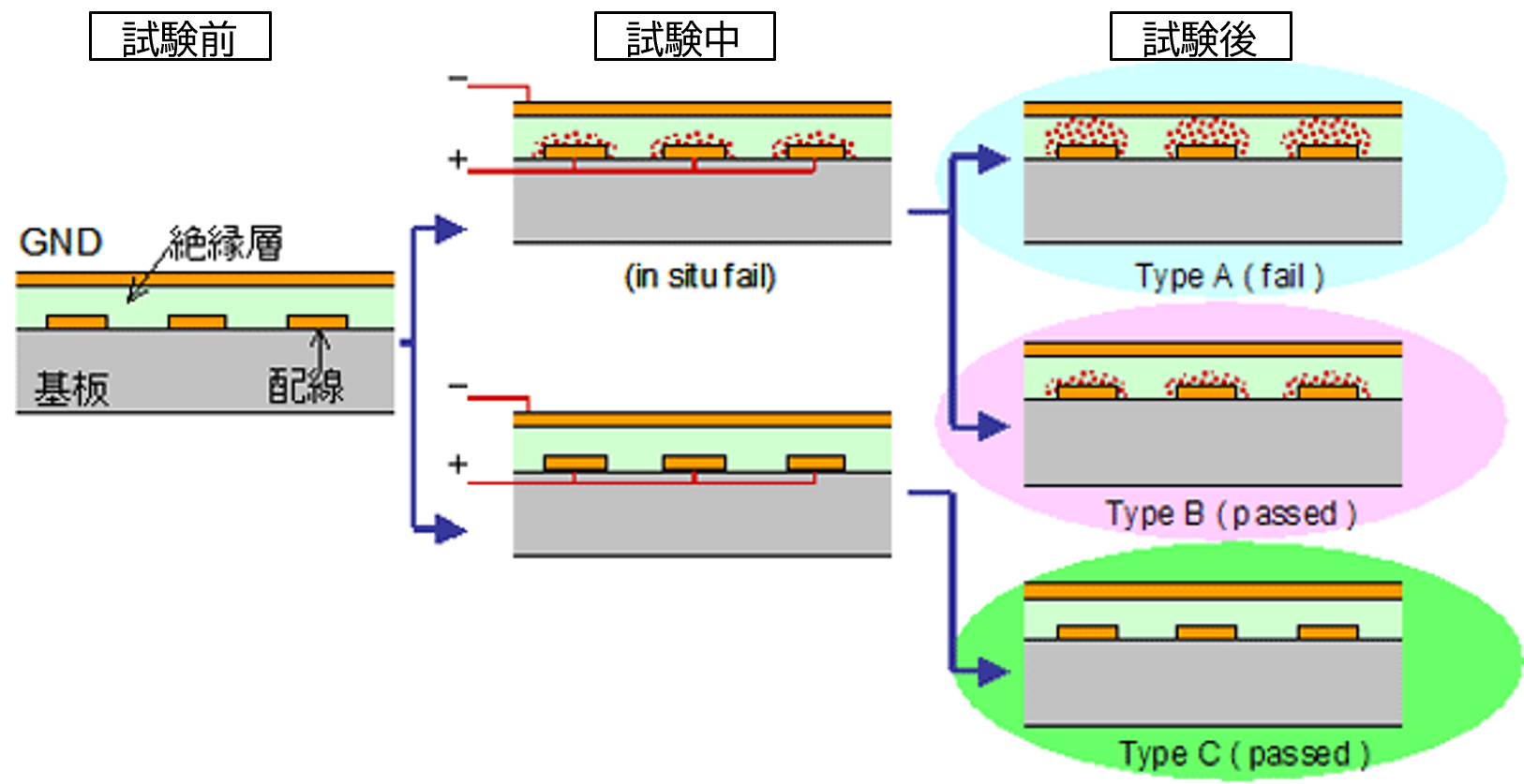
電気配線間のイオンマイグレーション性評価試験例
高温高湿環境でのin situ抵抗測定(イオンマイグレーション試験)
試料タイプにより絶縁抵抗の経時変化に明らかな違いがみられます。イオンマイグレーションは温湿度環境と直流バイアス電界により、例えばプリント配線板の導体(Cuなどの配線材料)が酸化還元を繰り返し、導体間で導電パスを形成されることで発生します。
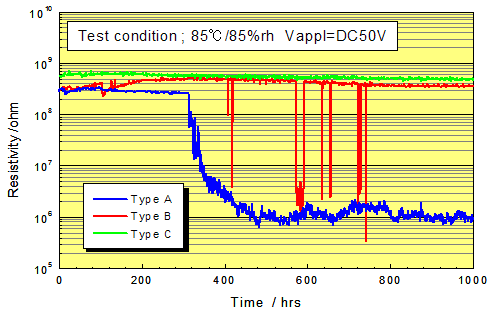
2.はんだ実装における評価技術
家電製品や自動車など、身の回りにある電子制御機器には、電子部品やコネクタを「はんだつけ」した実装基板が組み込まれています。実装基板において「はんだ接合部」の状態(初期欠陥)や経年劣化による接合不具合が原因で、製品の発火・発煙と言った重大事故や、システム動作不良と言った問題が報告されています。
当社では、はんだ実装における各種評価技術をご提供いたします。お客様の安全・安心な電子機器の開発や品質保証の手段・手法としてご活用いただいております。
コネクタ挿入部品で観察された「はんだ」の欠陥調査例

「はんだ」欠陥発生のメカニズム
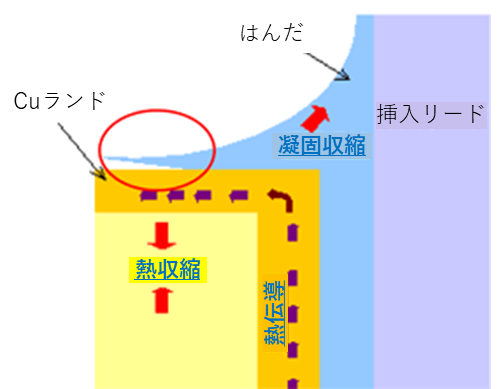
BGA実装における不具合現象の調査例
BGA(Ball Grid Array) 部品のはんだ実装においては、リフロー炉によるはんだ接合後の残留応力低減や、界面化合物の制御が不十分な状態にあると、残留応力や耐衝撃性低下といった原因で接合面のクラック発生等、実装不具合が生じることがあります。
実装不具合部の観察
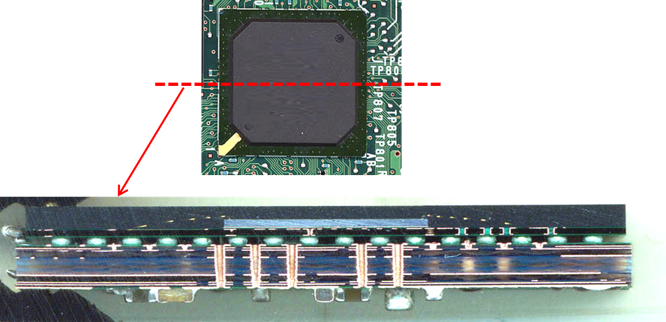
はんだ接合部の拡大
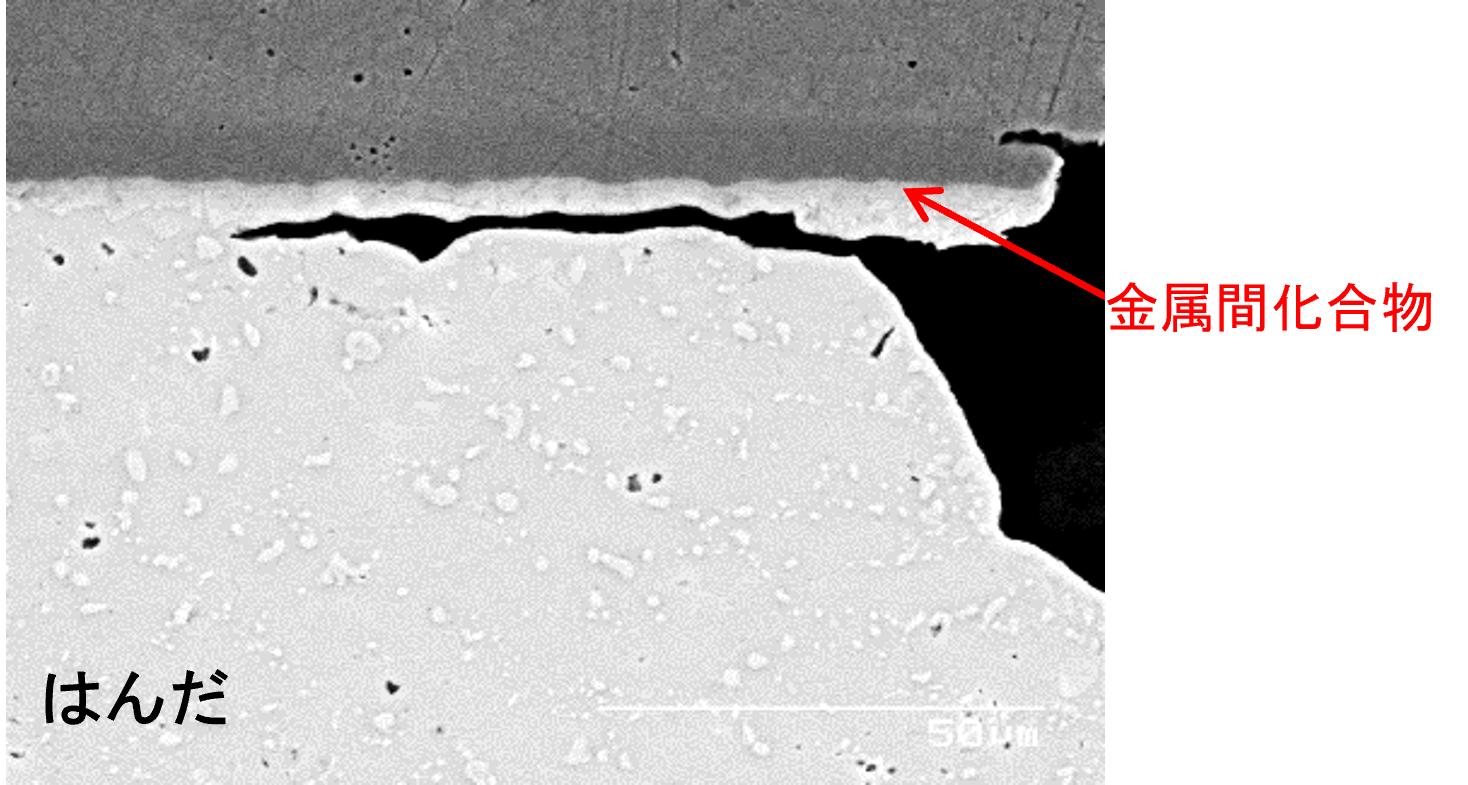
繰返し熱疲労によるクラック(金属間化合物とはんだ界面で徐々に剥離しています)
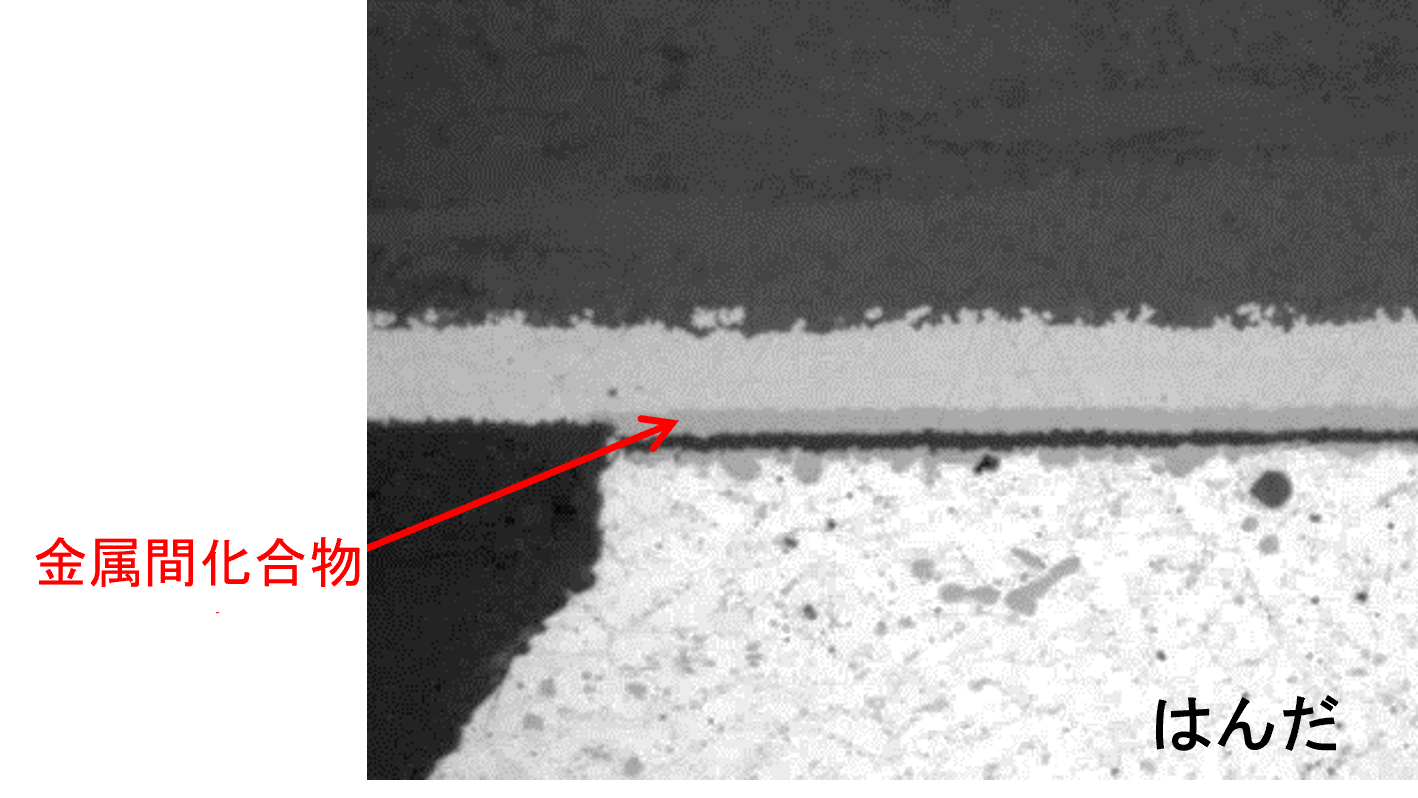
衝撃による脆性クラック(金属間化合物とはんだ界面が高速で剥離しています)
BGAの接合強度評価の例
温度サイクル試験、振動試験、衝撃試験、繰り返し疲労試験等の前後で接合強度測定を行い、プリント配線板の各種不具合(ブラックパッド、ルーズコンタクト、接合不良等)との関連性を評価します。
試験方法の模式図、実際に試料に治具を接着した写真、引張り試験を実施している写真を示します。
BGAプル試験機
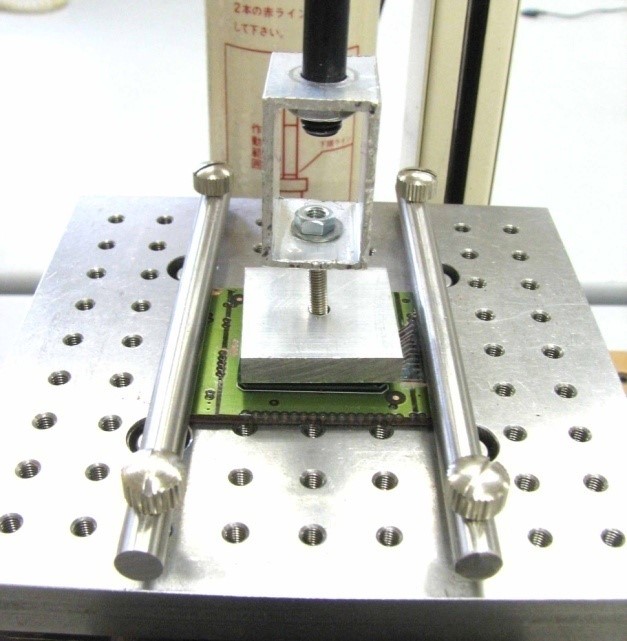
BGAプル試料
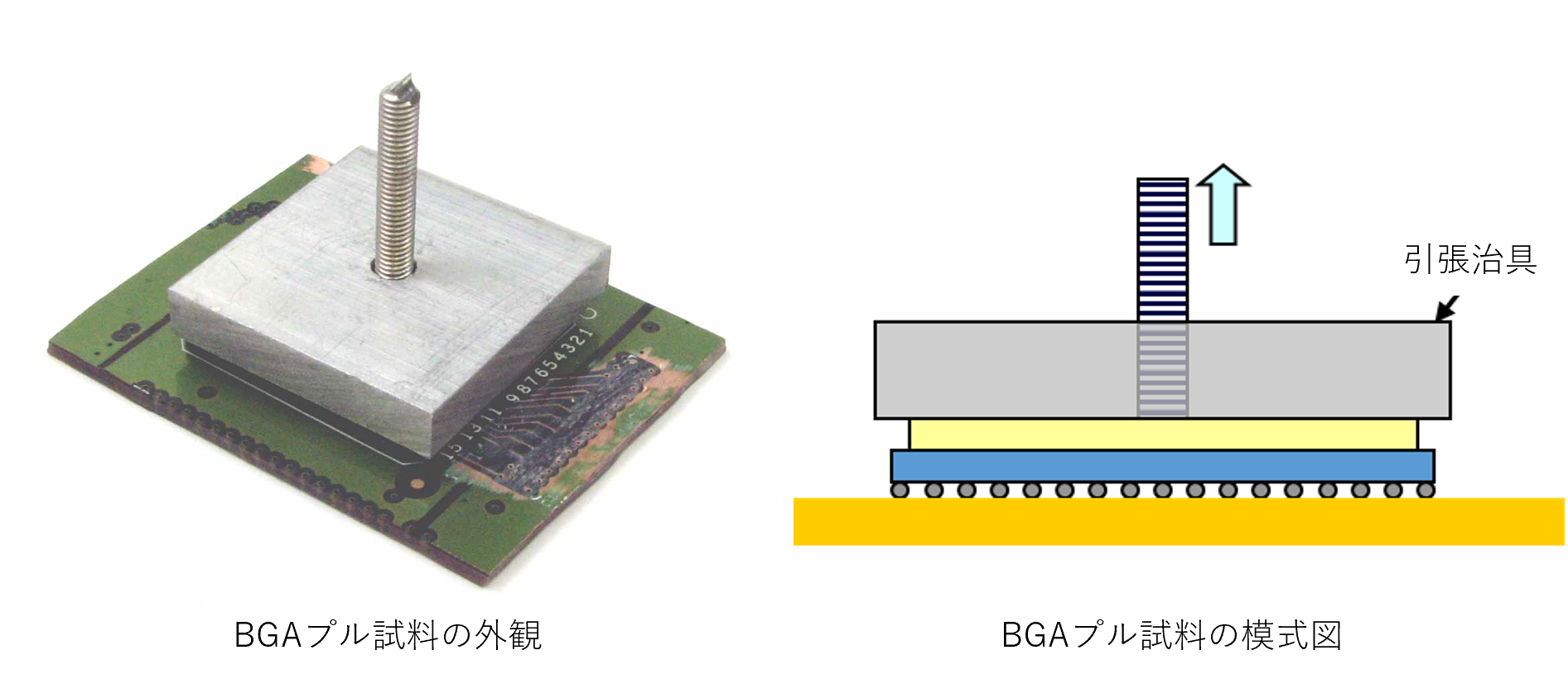
測定結果は強度-変位グラフで示し、最大値を接合強度とします。
また、BGA剥離面とプリント基板面双方のはんだ剥離状態をマイクロスコープで観察、はんだ接合状態の健全性を確認することで不具合要因を考察いたします。
BGAプル試験測定結果例
測定結果は強度-変位グラフで示し、最大値を接合強度とします。
また、BGA剥離面とプリント基板面双方のはんだ剥離状態をマイクロスコープで観察、はんだ接合状態の健全性を確認することで不具合要因を考察いたします。
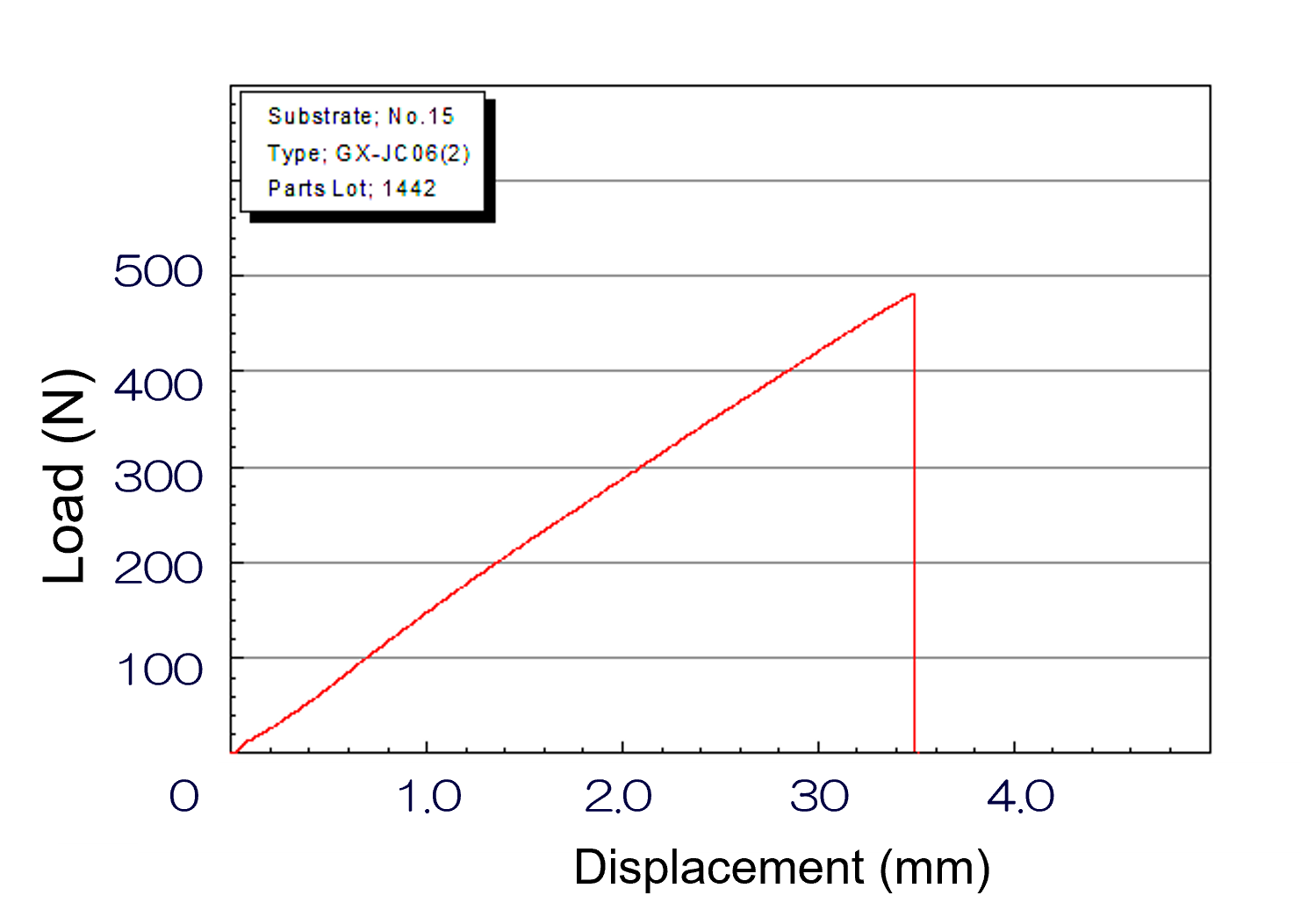
BGAプル試験後の観察
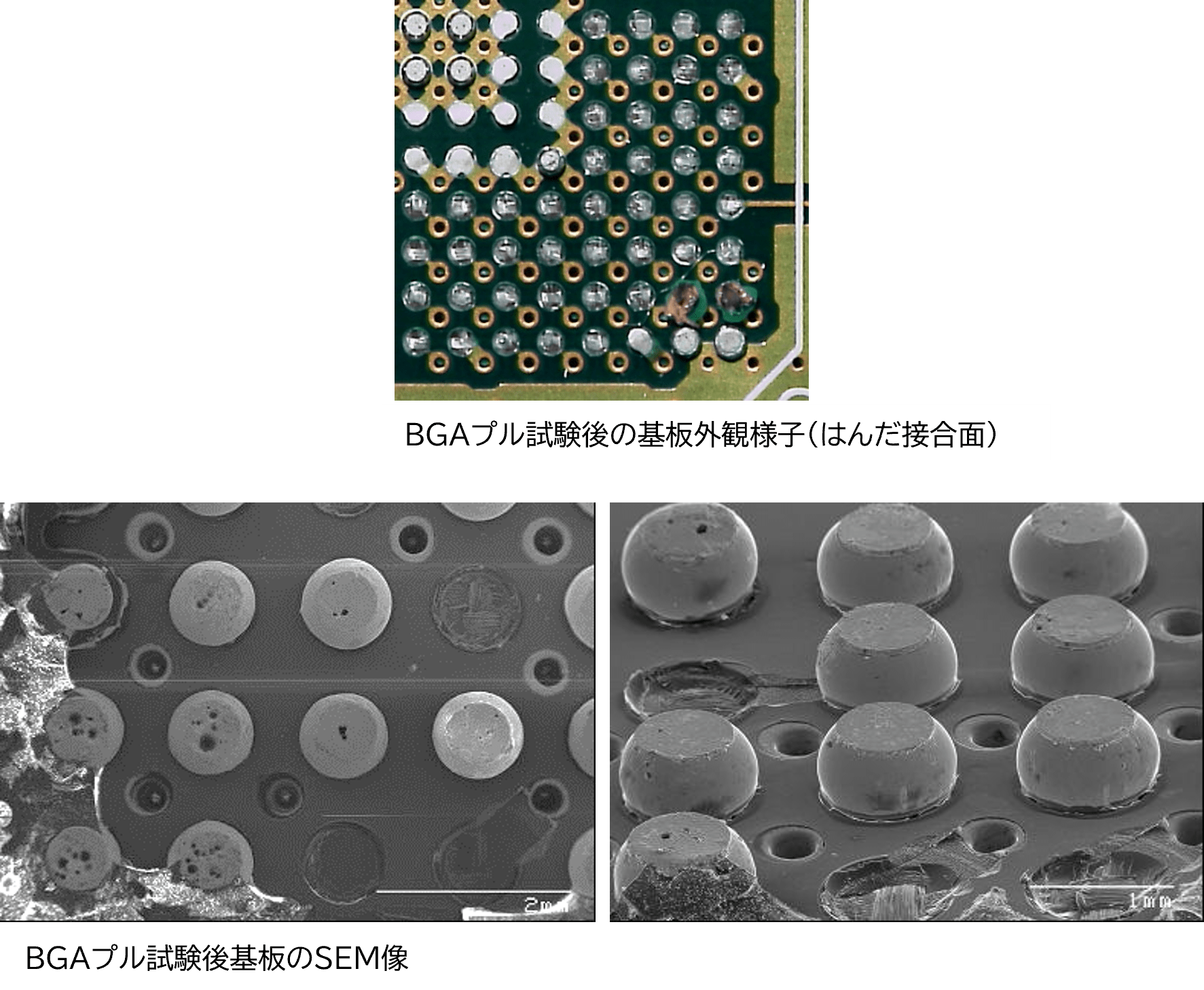
3.パワーデバイスの接合強度評価
ベアチップのはんだ接合強度試験の例
パワーデバイスを用いた基板では、ベアチップ、金属ワイヤーを高放熱基板へはんだ実装し回路を構成するケースが多い。
パワーデバイスは、大電流・大電圧を用いるため、実装基板自体の温度変化量が多く、使用経過によって各材料の線膨張係数の違いに起因するはんだ接合部位のワレ、カケなどが発生しかねない。

当社では、各デバイスに合った治具製作から、はんだ接合部の接合強度判断に必要なせん断試験について、ご提案をさせていただきます。

LEDデバイスの不具合解析の例
LED発光デバイスは、発光素子(ベアチップ)と高放熱基板(アルミナ、窒化アルミ)と電気接続(ボンディングワイヤ、はんだ)し、構成されている。
発光素子は点灯(電流on)と同時に高温、消灯(電流off)で低温となるため、基板との間で線膨張係数の違いによる接合界面ひずみが生じる恐れがある。
LED素子の外観
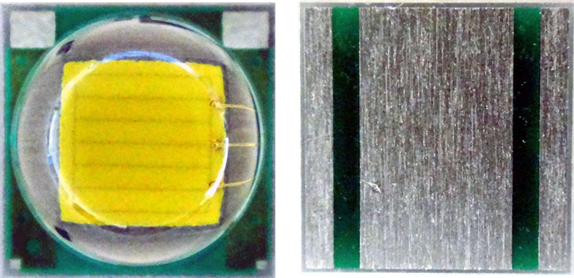
LED素子の断面
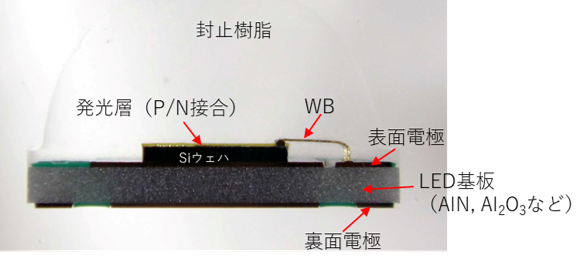
温度サイクル試験実施後の表面実装LED素子の断面像
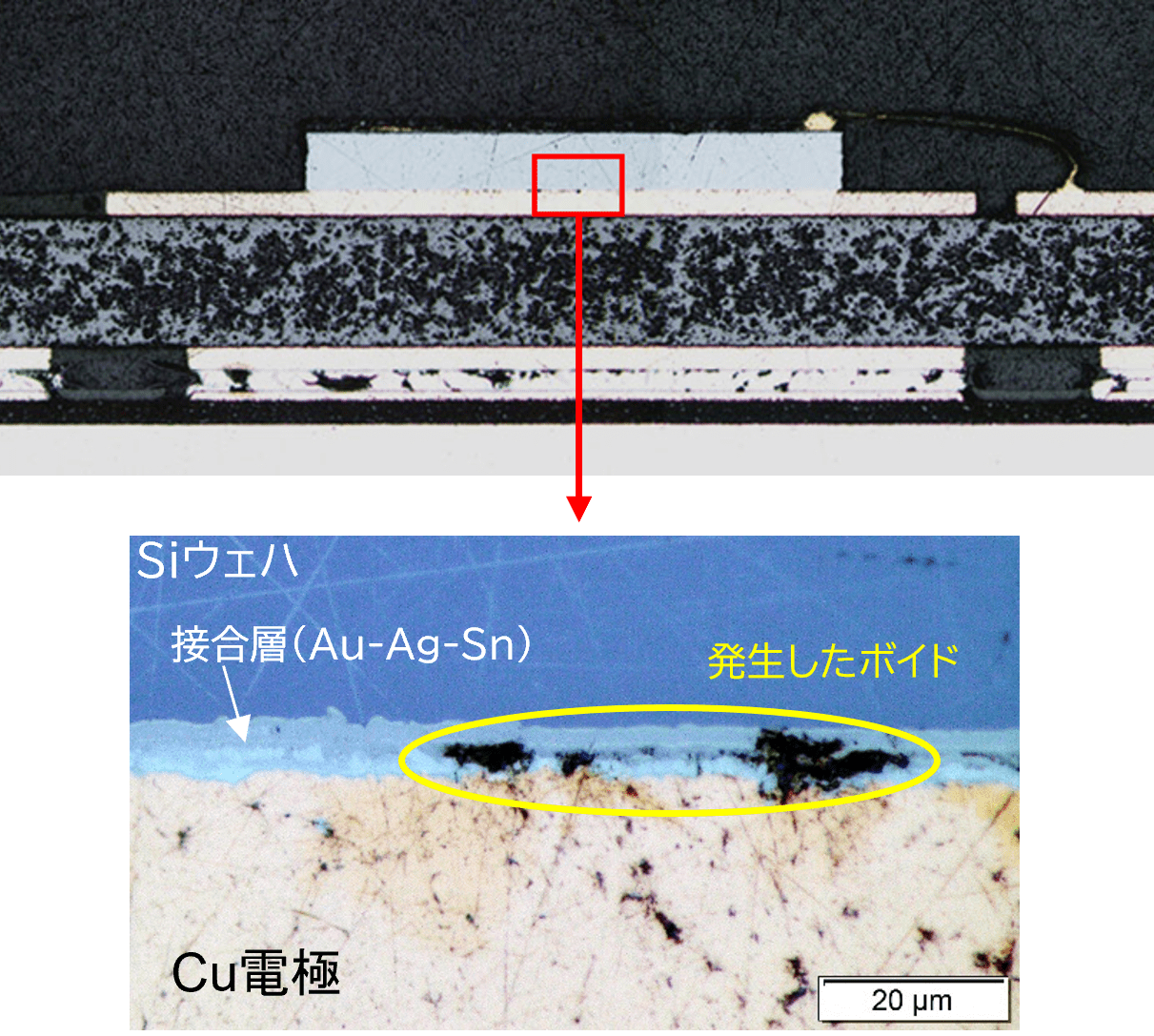
試料に熱履歴(低温・高温の繰り返し)を施したところ、ベアチップと基板配線との接合箇所(はんだ接合)に、空隙(ボイド)が観察されました。
これは、ベアチップ(Si)と基板配線(Cu)、接合材(はんだ:Au-Ag-Sn)との形状の違い・線膨張係数の違いに起因する接合破断になります。
接合破断により、LED不点灯や輝度不良などの機能面での問題が生じます。
当社では、お客様からの試料をお預かりし、各種機能検査、環境試験のご提案から、不具合解析を通じた原因調査・考察を行います。

