透過X線トポグラフによるSiのスリップ転位評価事例
FTM-1615
8インチSiウェハのスリップ転位の評価事例
X線トポグラフィ解析(XRT)の技術紹介はこちらから
透過X線顕微鏡法(TEM)の技術紹介はこちらから
透過X線トポグラフによるスリップ転位の評価
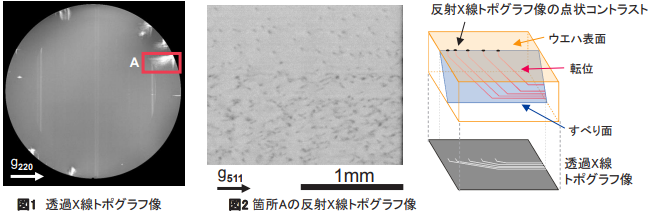
透過X線トポグラフではスリップ転位は白いコントラストとして映ります(図1)。
領域Aを反射X線トポグラフで観察すると、黒い点状のコントラストが並んでいるのが確認できます(図2)。これは、スリップ転位がウェハ表面に貫通した箇所に相当します。
スリップ転位のTEM観察
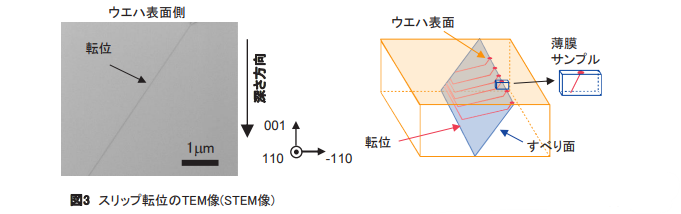
スリップ転位がウエハ表面に貫通した箇所から薄膜サンプルを作成してTEM観察すると、転位に相当する線状のコントラストが確認できます。
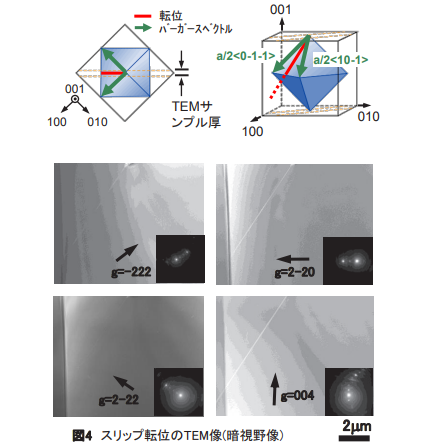
gベクトルと転位のバーガースベクトルが直交すると転位のコントラストが消失します。図4の結果から、ウエハ表面に抜けるスリップ転位は<112>方向に伸びており、バーガースベクトルは転位線に対して30度の角度を持つことがわかります。