透過X線トポグラフによるSi中スリップ転位の断面観察事例
FTM-1614
透過X線トポグラフによる平面/断面トポグラフの測定原理
X線トポグラフィー解析(XRT)に関する技術解説はこちらから
X線透過顕微鏡法(TEM)に関する技術解説はこちらから
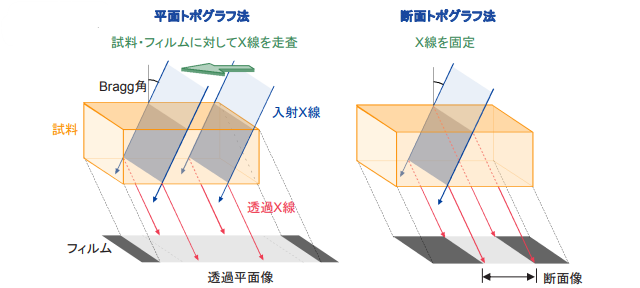
透過X線トポグラフ法では、試料・フィルムに対してX線を走査しながら撮影することで試料全体の透過平面像を得ることができます(平面トポグラフ法)。一方で、X線を試料の一箇所に固定して撮影することで、試料の断面像を得ることも可能です(断面トポグラフ法)。
8インチSiウェハのスリップ転位の評価例
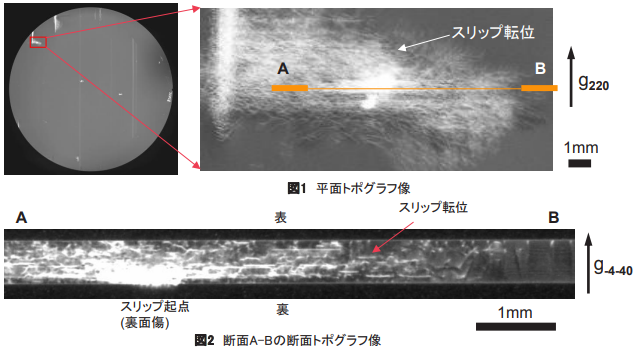
8インチSiウエハのスリップ転位を平面トポグラフ、断面トポグラフで撮影した例です。ウエハの裏面傷を起点にしてスリップ転位が発生している様子がわかります。