SiC表面極薄膜の透過電子顕微鏡(TEM)観察
FTM-1613
1.はじめに
FIB(集束イオンビーム)は、通常微小領域の断面観察やTEM観察用薄膜試料作製に用いられています。また、試料表面に保護膜を形成する際、Gaイオンビームではなく電子線を用いて保護膜を形成することで、試料最表面の極薄膜(数nm~数十nm)の観察分析が可能となります。
試料最表層の状態は材料特性や接合等に大きな影響を与え、当社の技術は試料表面の形状観察、拡散状態の把握、結晶構造の解析に威力を発揮します。
集束イオンビーム加工(FIB)の技術紹介はこちらから
透過電子顕微鏡法(TEM)の技術紹介はこちらから
2.装置条件;加速電圧と像分解能
| FIB | 加速電圧1~40kV 像分解能 5nm@40kV |
|---|---|
| SEM像観察 | 加速電圧0.5~30kV 像分解能 1.0nm@15kV |
※透過電子顕微鏡像(TEM)観察可能、EDSによる成分分析が可能
3.事例;レーザーアニールを行ったSiC基板の観察
当社のFIB技術は試料最表面、膜厚10nmの極薄膜でも試料本来の状態を観察することが可能です。
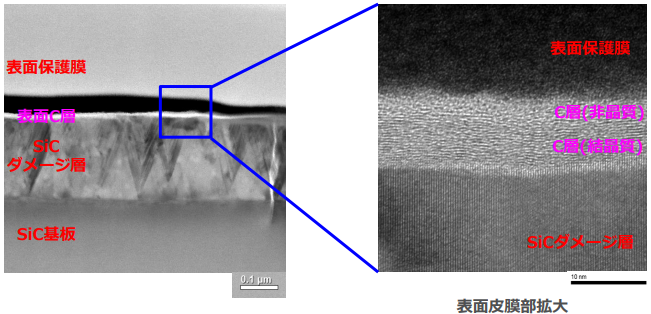
試料提供 千葉工業大学 工学部 電気電子工学科 教授 山本 秀和 様


