FIB試料を用いたTEM分析~自動車用ホットスタンプ材への適用事例~
RSM-2503
1.概要
集束イオンビーム-走査電子顕微鏡(FIB-SEM)は、FIBによる微細加工とSEMによる高分解能観察ができる複合装置です。また、透過電子顕微鏡(TEM)観察用薄膜試料を作製できるため、目的に沿った微小領域の観察・分析、結晶構造解析をおこなう際に役立ちます。
- ◎適用材料:金属材料,半導体,セラミックス,触媒等
- ◎加工可能範囲:約10x10µm
- ◎熱影響を受けやすい試料はクライオ加工可能 ※参考資料;Technical Report No. FTM-1605
透過電子顕微鏡法(TEM),走査透過電子顕微鏡法(STEM)の技術紹介はこちらから
集束イオンビーム加工(FIB)の技術紹介はこちらから
2.事例;自動車用ホットスタンプ材におけるFe/Al界面部のSTEM-EDS分析
●FIBによる観察目的箇所のサンプリング方法
バルク材からのFIBによるサンプリング方法は断面サンプリングと平面サンプリングから選択できます。
本事例はFig.1に赤枠で示した明瞭な界面が認められる箇所を調査するため、平面サンプリング(Fig.2)によりTEM観察用薄膜試料を作製しました。
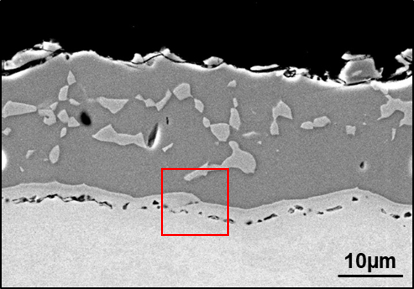

●FIB加工により作製した薄膜試料の観察とEDSによる元素分析
FIB加工により作製した薄膜試料は<100nm程度と薄く、バックグラウンド信号が軽減されるため、局所的な分析も可能です。
Fig.3に示すSTEM-EDS元素マップ重複画像にはアルミめっき/鋼板界面部で元素の相互拡散により形成した合金相が層状に存在していることが確認されます。その他、TEM観察技法を駆使することで目的に寄り添ったデータのご提供が可能となります。

- ・組織観察 :TEM・STEMによる最適なイメージング
- ・元素分析 :EDS分析(B以上) スポット径;Cs-STEM 0.1nm~ 、FE-TEM 1nm~
- ・結晶構造解析:各種電子回折図形(SAED,NBD,CBED) ※参考資料;Technical Report No. RSM-2502


