顕微ラマン分光を用いたSiCウェハ表面のダメージ評価
RSM-2403
1.概要
SiCをはじめとするワイドギャップ半導体の普及が拡大していく中、単結晶インゴットから切断加工してウェハを作製するプロセスの高速化が求められています。切断加工時にウェハへ残留するダメージは後のプロセスを効率よく進めるためにも極力小さい事が求められます。このダメージ評価方法の一つである顕微ラマン分光法は、数μmレベルの局所領域を評価することが可能です。
本事例では、SiCウェハの加工ダメージを模擬した試料を作製し,顕微ラマン分光法を用いて評価した結果をご紹介いたします。
2.分析方法
評価試料;切断加工を模擬したダメージを導入した市販4H-SiCウェハー
顕微ラマン分光分析条件;励起波長532nm、倍率100倍(NA=0.90)にて深さ方向のライン分析
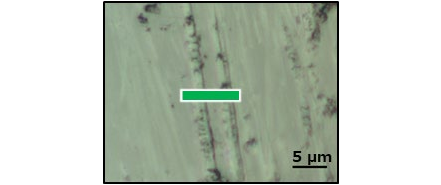
3.分析結果


※表示上の深さ方向Zの屈折率補正(SiC:~2.6)は行っていません。
左図は4H-SiCに特徴的なピーク(776.5 cm-1)のシフト量を、右図は同様にピークの半値幅をカラースケールで表示しました。縦軸はSiCウェハの深さに相当する量を示し、0が表面、マイナス方向が深部に向かう方向です。
ピークシフト量は、一軸応力を仮定した場合、暖色系は圧縮応力、寒色系は引張応力が残留しているとみなすことができ、ダメージ部にはさまれた領域には引張応力が、その両側の領域には圧縮応力が存在していることが確認できました。
さらに、深さ方向への影響も確認することができます。一方,半値幅の広がりは、一般的には結晶性の低下と相関があり、引張応力領域で結晶性がより大きく低下していることがわかりました。


