めっき層の六価クロムの検出~RoHS指令規制物質~
RSM-2205
1.概要
金属部品の表面処理法として、高耐腐食性や高硬度の利点がある六価クロムを使用したクロメート処理が従来使用されてきましたが、現在は六価クロムがRoHS指令規制物資に指定されていることから、めっき等薄膜中の有無について評価が求められます。
本報では、めっき等薄膜中の六価クロムの有無を調べるために、高エネルギーX線を用いた光電子分光法(HAXPES*1)を用い、有色クロメート処理部品を試料として調査した事例を紹介いたします。
クロムの化学状態の評価手法としてはX線光電子分光法(XPS*2)が一般的ですが、HAXPESではXPSよりも深い情報(~数十nm)が得られることから、従来困難であったイオンスパッタリングを併用しながらのめっき全体の六価クロム分析が可能であることを示します。
*1 HAXPES:Hard X-ray Photoelectron Spectroscopyの略 HAXPESの技術紹介はこちらから
*2 XPS:X-ray Photoelectron Spectroscopyの略 XPSの技術紹介はこちらから
2.調査試料と測定装置
| 試料 | 有色クロメート処理を施した金属部品 |
|---|---|
| 装置 | ULVAC–PHI 社製 PHI Quantes |
| X線源 | HAXPES(Cr Kα,) ※検出深さ 数十nm XPS (Al Kα) ※検出深さ 数nm |
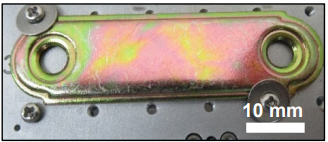
3.分析結果-HAXPESとXPSによるCr2p3/2スペクトルの比較-
- イオンスパッタリング前では、両手法ともに六価クロムCr6+と三価クロムCr3+がピークとして検出されています。またXPSでは表面変質層(Cr3+)の影響を強く受け、Cr6+の強度が低くなっていると考えられます。
- 40nmイオンスパッタリング後、XPSではダメージ層が形成され、Cr6+が検出されなくなりました。一方HAXPESではCr6+が検出されており、めっきの深い領域にもCr6+が存在していることを示しています。
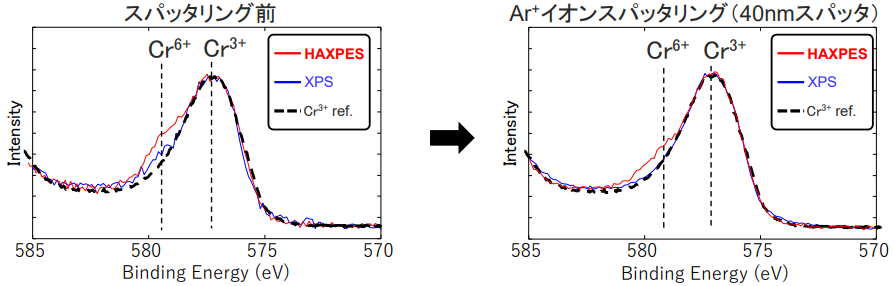
4.まとめ
本事例のようにHAXPESを用いて、表面汚染層や表面変質層の影響を抑えた分析データをご提供致します。またXPSと併用する事で、物質表面数nm~数十nmにおける組成や化学結合状態を評価する事も可能です。界面、電池、触媒、トライボロジー、多層膜など種々の分野・材料に応用することができます。