Cs-TEMによる原子レベル高分解能での極微小組織の材料解析
FTM-2011
1.概要
球面収差補正-透過型電子顕微鏡(Corrector-Spherical Aberration-Transmission Electron Microscopy, Cs-TEM)は、対物レンズおよびコンデンサーレンズの球面収差補正を行うことで、より高分解能なSTEM像とHAADF像の撮影と、高強度極微細プローブによる原子列からの元素分析が可能な装置です。
従来のSTEMマッピングでは得られなかった原子レベルの高分解能STEM-EDSマッピング(元素存在位置情報)を得ることが可能です。
2.高分解能Cs-TEMを用いた高度測定・解析
| STEMによる結晶の格子像観察 | 従来TEMの約10倍向上したSTEM分解能(0.1nm)により、STEMによる結晶の格子像を観察可能 |
| 原子レベルの 高分解能EDS-マッピング |
高強度の極微細プローブ(0.1nm)により、B以上の全元素を対象とした原子レベルの高分解能EDS-マッピングが可能 ※元素定性分析/半定量分析/存在位置情報の撮影 |
| 複数種の析出相、 成膜等の分離同定・解析 |
電子回折パターンとEDS分析の解析により、複数種の析出相や成膜が存在した場合に於いても、各結晶構造を明らかにし、数nmレベルの析出物を同定することが可能。 |
| 電子線に弱い材料への適用 | 低加速電圧(80KV)観察機能により電子線に弱い材料も対応可能。 |
3.Cs-TEM活用事例;鋼中の粒界偏析および析出物
鋼中の粒界偏析および極微細析出物(NbC:⻑さ10nm 幅0.5nm)のCs-TEM分析事例を示します。
析出物NbC(Cubic)の構造同定はEDS分析および電子回折により決定しています。
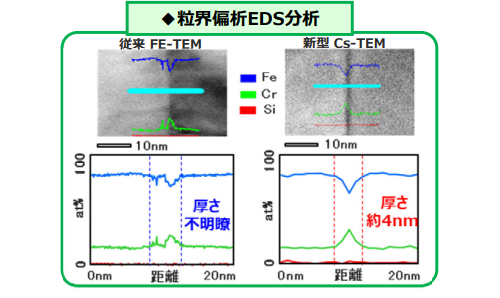
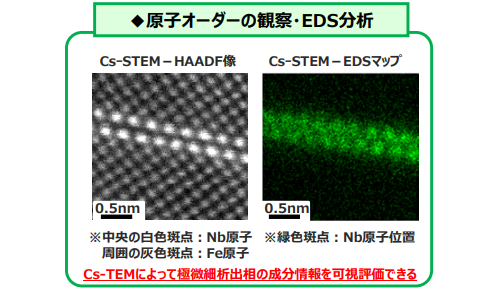
およびEDS-マッピング(右)結果
Cs-TEMでは従来TEMでは難しかった数nmレベルの極薄膜(不働態被膜、粒界偏析、析出物など)の明瞭なEDS(点、ライン、マッピング等)情報を得ることが可能です。


