透過電子顕微鏡(TEM)による転位の解析
FTM-1619
概要
透過電子顕微鏡(Transmission Electron Microscopy, TEM)は試料に電子を照射し、試料を透過した電子を検出して、観察と分析を行う手法です。1μm程度の微小物の観察から原子配列の直接観察まで、目的に応じて数万倍~100万倍程度まで倍率を設定して観察することができます。形状の観察に加えて、回折、散乱、励起等の現象を利用して、結晶構造や含有元素の種類の決定、析出、偏析の定量のほか、転位等の欠陥に関する情報が得られます。
装置仕様
(1)最大倍率120万倍で、微小領域の観察とΦ1nmでの分析が可能です。
(2)分解能0.1nmで、結晶の格子像を観察できます。
(3)特性X線(EDS)の測定と電子エネルギー損失スペクトル(EELS)の測定により、元素の識別と定量が可能です。
(4)電子回折パターンの解析により、結晶構造を明らかにし、数nmの析出物でも同定可能です。
(5)弊社では、独自に開発した電子回折パターンの自動解析ソフトを用いて、観察しているその場で瞬時に結晶構造を解析可能です。
測定事例;サファイア基板上GaNの転位の解析
サファイヤ基板上のGaNの断面TEM観察結果です。
明視野及び暗視野像観察により、転位の挙動、バーガースベクトルの決定を行っています。
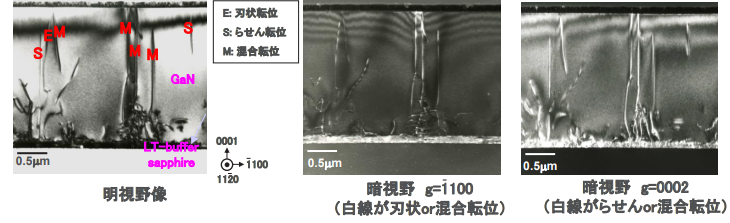
| バーガースベクトルb | 転位の種類 | 回折ベクトルg | |
| -1100 | 0002 | ||
| 1/3<11-20>(刃状転位) | ○ | × | |
| <0001>(らせん転位) | × | ○ | |
| 1/3<11-23>(混合転位) | ○ | ○ | |
※g・b=0を満たすとコントラストが消滅


