半導体分野におけるプラズマFIB(PFIB)-SEMの活用
RSM-2602
1.概要
PFIB※-SEMは、Xeなどのプラズマをイオン源として利用するFIB-SEM装置です。ICP(誘導結合プラズマ)の原理に基づき、ガスに高周波電力を印加してプラズマを生成し、そのイオンビームを集束・偏向して試料に照射することで、局所領域の加工と像観察を行います。
プラズマ励起によるイオンは、幅広で平行なビームを形成でき、使用可能な電流量は従来の液体金属(Ga)を用いたFIBに比べて数十倍に達します。そのため、数百μmオーダーの広域加工に適しています。
更にPFIBには以下の特徴があります。
- ・不活性ガスの使用により、試料との反応やダメージを抑制できる(Gaフリー加工)。
- ・Xe、Ar、Oなど複数のイオン種を選択可能で、材料や目的に応じた加工が可能。
これらの特性により、半導体解析の高精度化・高品質化に大きく貢献しています。
※PFIB;Plasma Focused Ion Beam
2.評価事例1:広域断面加工・観察
PFIB-SEMは、Ga-FIBの数十倍のビーム電流を実現し、従来は数十μm角だった加工範囲を数百μmオーダーまで拡大できます。これにより、広域の断面観察を高位置精度で行うことが可能です。
IC製品のワイヤボンディング部をPFIBで断面加工したSEM像では、接合界面の形状からワイヤの結晶組織まで一断面で評価できています。
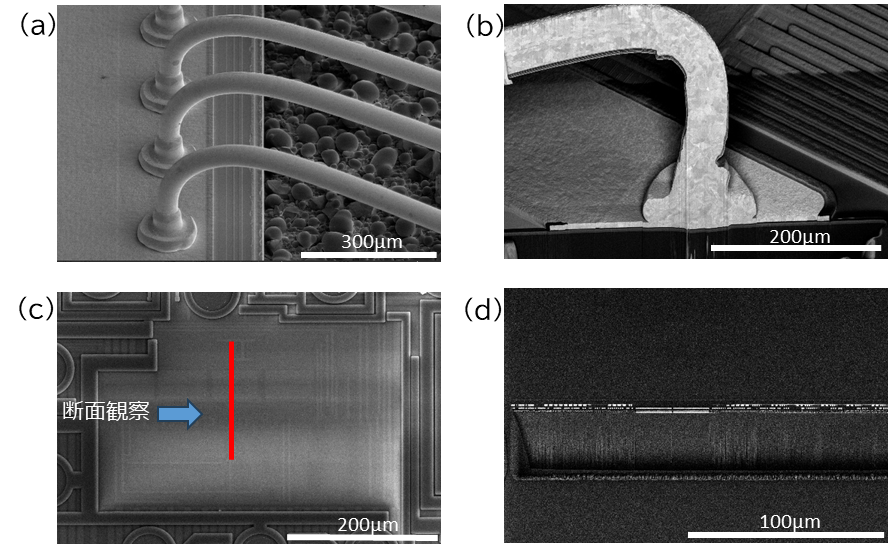
3.評価事例2:半導体デバイスの拡散層可視化
FIBによる断面加工とSEMの電位コントラスト法(Voltage ContrastVC)を組み合わせることで、半導体デバイスの拡散層形状を可視化できます。
SiC-MOSFETについて、Ga-FIBとPFIBで加工した断面形状を比較しました。
従来のGa-FIBによる断面加工では、Gaイオン照射によるダメージの影響でPN接合が不鮮明ですが、PFIBを用いることで拡散層のコントラストが明瞭に確認できます。
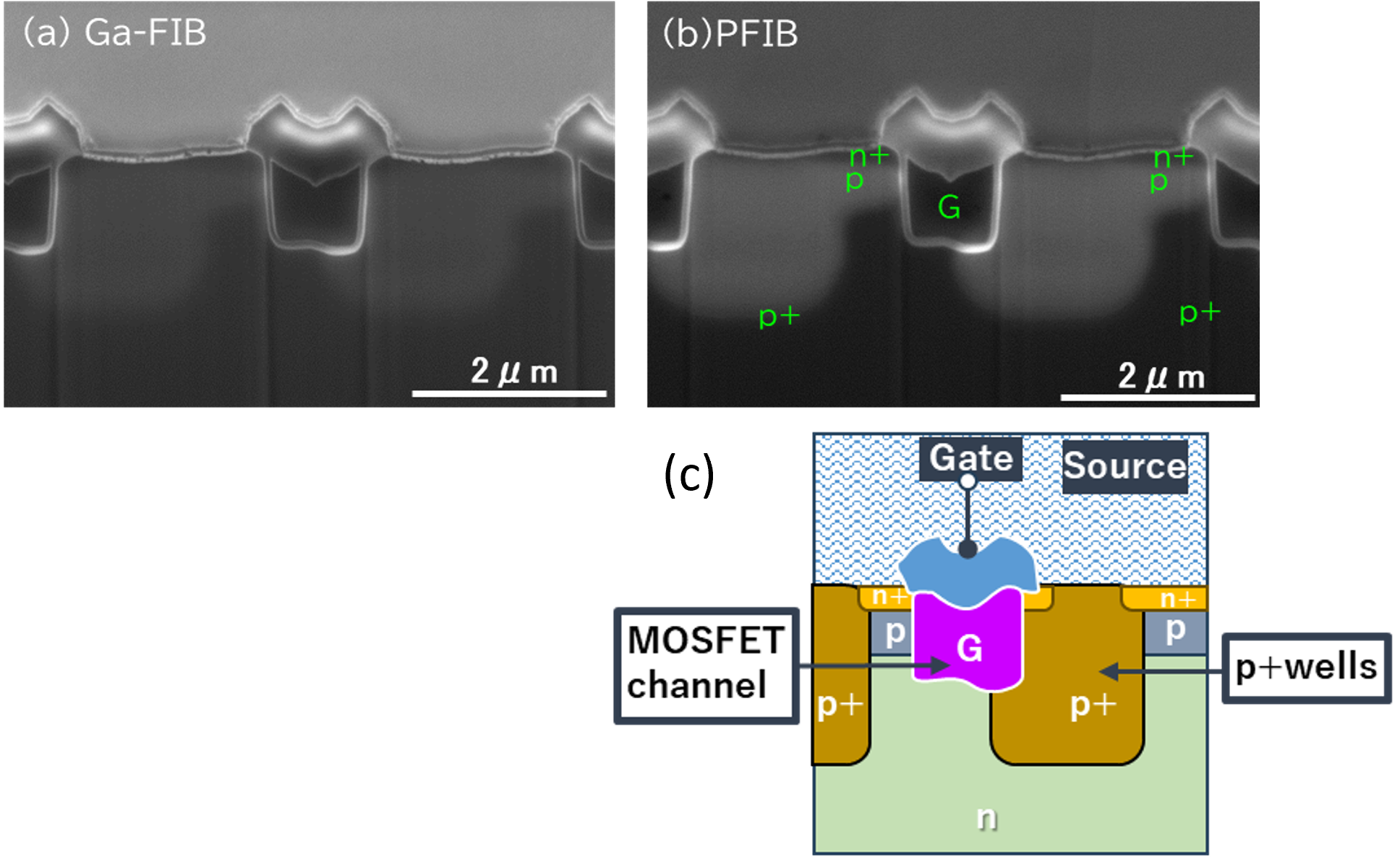
4.評価事例3:化合物半導体の低ダメージTEM試料加工
PFIBはTEM試料加工の高品質化においても大きなメリットがあります。Xe,Arといった不活性元素で加工できるため、Ga-FIBで問題になっていた打ち込みイオンと材料の反応による問題を解消できます。また、Xeはイオン半径が大きく、試料表面近傍でスパッタリングが起こるので、ダメージを低減できます。
GaN-HEMTのAlGaN/GaN超格子層をGa-FIBとPFIBで加工したTEM試料を比較した結果、Ga-FIBでは斑点状のダメージが形成されるのに対し、PFIBではそれが抑制されており、より高品質な試料加工が可能になります。