Ar-GCIB-TOF-SIMSによる有機多層膜の分析~有機ELの深さ方向分析事例~
AMM-2009
1.概要
有機ELなど、有機多層膜の各層の化学構造や積層構造に関する情報取得には、試料ダメージが小さい低エネルギースパッタのアルゴンガスクラスターイオンビーム(Ar-GCIB:Argon-Gas Cluster Ion Beam)を用いた、飛行時間型二次イオン質量分析(TOF-SIMS:Time Of Flight Secondary Ion Mass Spectrometry) が有効です。
本レポートでは、有機EL素子を対象試料とし、Ar-GCIBを用いたTOF-SIMS分析によって、1マススペクトル分析で得られた有機物の化学構造を反映した分子イオンを指標としながら、2各物質の深さ方向の分布情報を得ることにより、積層構造を解析した事例をご紹介いたします。
飛行時間型二次イオン質量分析(TOF-SIMS) の技術紹介はこちらから
2.Ar-GCIBの特徴
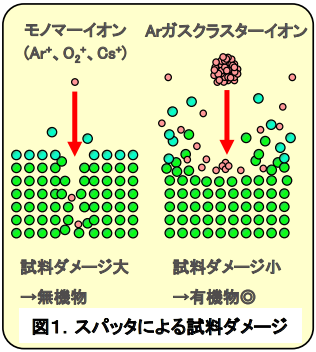
3.有機多層膜試料の試料情報
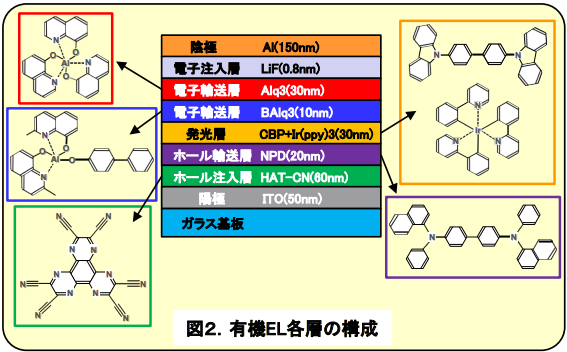
4-1.測定結果;マススペクトル分析による有機構造の分別
図3に示すように、マススペクトル分析では各層の有機物の化学構造を反映した分子イオンが検出できることから、有機構造の分別が可能です。
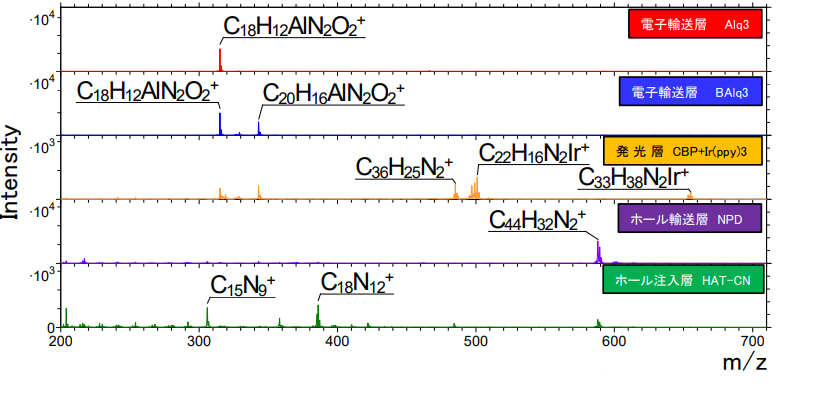
4-2.測定結果;深さ方向分析による積層構造の評価
深さ方向分析において、表面スパッタにa)通常のArモノマーとb)Ar-GCIBをそれぞれ用いて測定した結果を図4に示します。Arモノマースパッタを用いた評価では、有機物は分解されて各層の評価ができませんでしたが、Ar-GCIBスパッタを用いた場合は、図3に示した化学構造を反映した分子イオンを指標として、有機ELの積層構造評価を行えることが判ります。
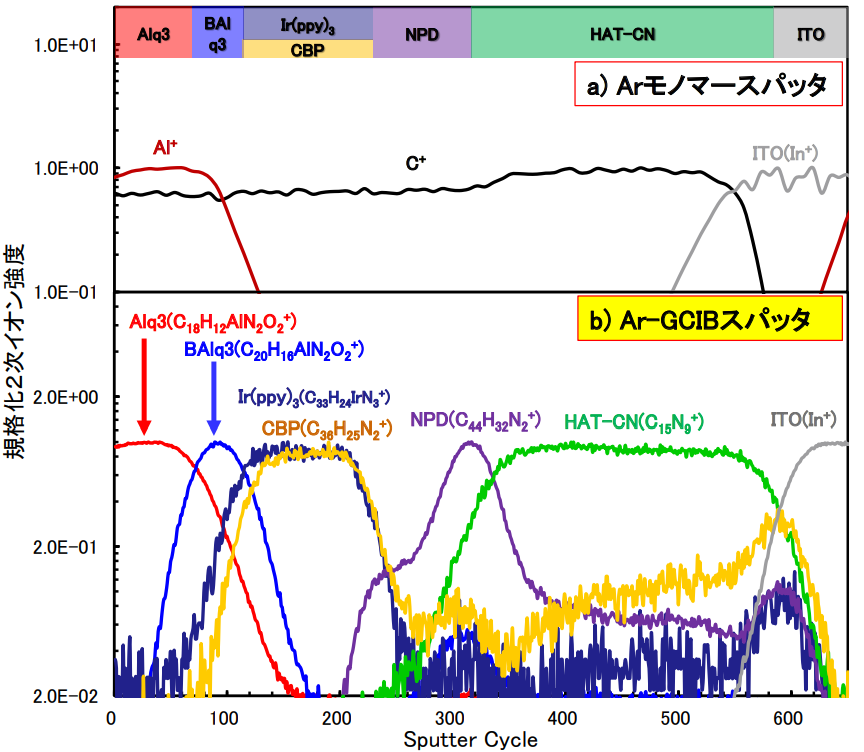
Ar-GCIB-TOF-SIMSにより有機多層膜の詳細な解析が可能